凸块是指按设计的要求,定向生长于芯片表面,与芯片焊盘直接或间接相连的具有金属导电特性的凸起物。凸块的材料可以是金属材料、无机材料或复合材料,用于建立芯片焊盘与基板焊盘之问的电互连,在一定范围内,可替代引线键合电互连方式。凸块工艺适用于引线框架、有机基板、硅基基板等倒装焊封装。
从20世纪 60年代IBM 公司开发出 C4 ( Controlled Collapse Chip Connection)凸块用于倒装芯片焊接工艺口以来,工业界已开发出金凸块 (Gold Burp)、焊球凸块(Solder Bump)、铜柱凸块(Pillar Bump) 等结构的凸块,如下图所示。
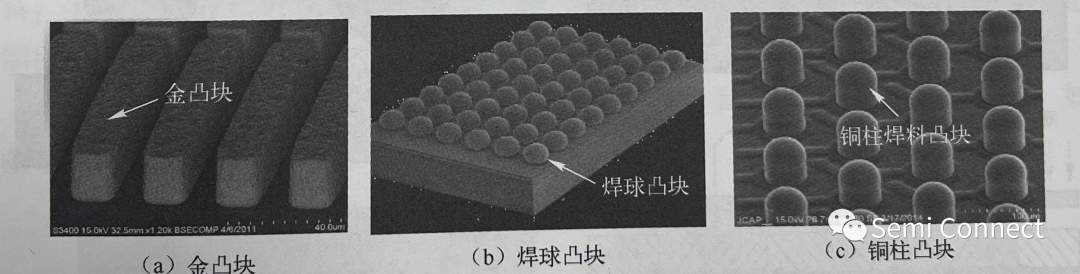
金凸块由凸块下金属(Under Burp Metallization, UBM)区电镀金组成,多用于液晶屏驱动芯片与玻璃或柔性基板的电互连,以及射频标签芯片与柔性基板的电互连。
焊球凸块由 UBM 和 UBM 上方的金属焊料 (Sn、SnPb、SnAg)组成,其结构特点是 UBM 薄(一般低于 10μm),焊料厚(从几十微米到一百多微米,或者更厚)。
铜柱凸块用电镀厚铜(数十微米)作为 UBM,同时适当降低焊料的厚度铜柱凸块可完全替代焊球凸块在倒装封装中的作用。铜具有良好的电学和热学性能,很好地改进了焊球凸块在电学性能和热学性能方面的问题。铜柱凸块因为其焊料薄的特点使其具备了窄节距的优点。
主流的凸块工艺均采用圆片级加工,即在整片园片表面的所有芯片上加工制作凸块,因此称为圆片级凸块工艺。常用的圆片级凸块工艺有了种,即蒸发方式印刷方式和电镀方式。日前,业界广泛采用印刷方式和电镀方式制作凸块。
在采用印刷方式制作凸块前,必须先在芯片表面需要生长凸块的区域制作UBM。 UBM 常用的加工方式有化学镀方式、溅射腐蚀方式和溅射电镀方式。下图所示的是电镀方式加工 UBM+印刷方式加工焊球凸块的工艺流程。
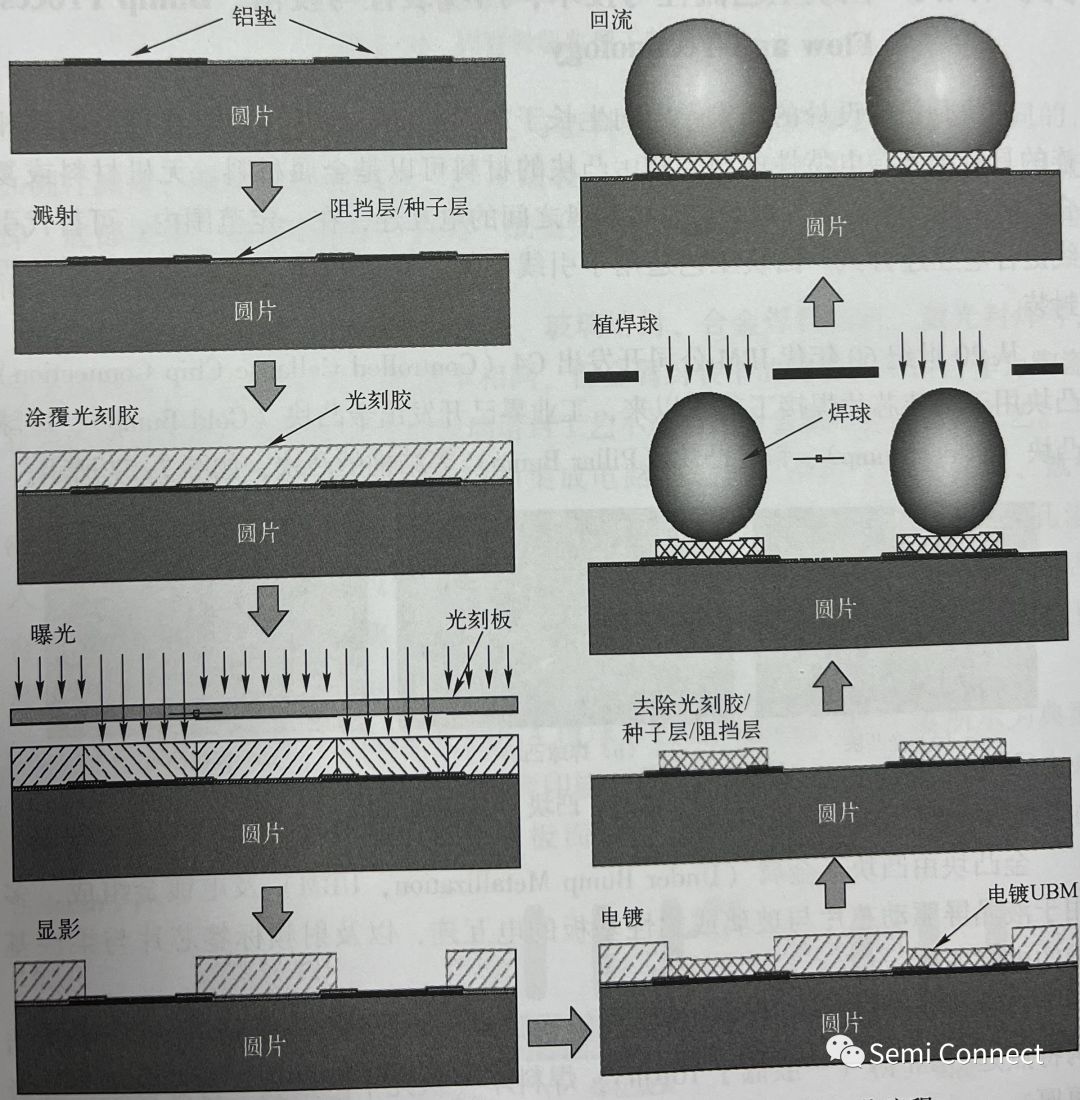
首先,采用溅射或其他物理气相沅积的方式在國片表面沉积一层钛或钛钨作为阻挡层,再沉积一层铜或其他金属作为后纹电锻所需的种子层;阻挡层起到阻挡芯片表面焊盘金属(如铝衬底)与和子层金属互扩散的作用,同时与这两层金属形成良好的结合力。在沉积金属前,四片先进人溅射机合的预湝洁腔体,用氩气等离子去除焊盘金 属表面的氧化层,以提高溅射金属层与芯片表面的结合力,以及降低金属氧化层引人的电阳。
其次,在圆片表面旋涂一定厚度的光刻胶,并运用光刻曝光工艺,对光刻胶进行选择性曝光,使光刻胶发生化学变化,以改变其在显影液中的溶解度。光刻胶与显影液充分反应后,得到设计所需的光刻图形。再则,圆片进人电镇机,通过合理控制电镀电流、电镀时间、电镀液液流电镀液温度、电镀液成分等,从光刻胶开窗因形的底部开始生长并得到一定厚度的金属层作为 UBM。在有机溶液中浸泡足够长时问后,圆片表面的光刻胶被去除;再用相应的腐蚀液去除圆片表面 UBM 以外区城的溅射种子层和阻挡层得到 UBM。
最后,在植球工序中,需要用两块开有圆孔的金属薄板作为掩模板,且开孔的位置与圆片表面 UBM 的位置相对应。在植球前,先用第 1块金属掩模板将助焊剂印刷到 UBM 表面;再用第2块金属掩模板将预成型的锡球印刷到 UBM上;最后,圆片经过回流炉使锡球在高温下熔化,熔化的锡球与 UBM 在界面上生成金属间化合物,冷却后锡球与 UBM 形成良好的结合。
采用电镀的方式也可以得到焊球凸块,即在电镀 UBM 完成后,接着电镀焊料;去除光刻胶和腐蚀溅射金属后,经过回流,得到焊球凸块。电镀方式也是铜柱凸块和金凸块加工的常用方法。
结合再布线(RDL)工艺,可以在芯片表面得到多种结构的凸块结构,如下图所示。
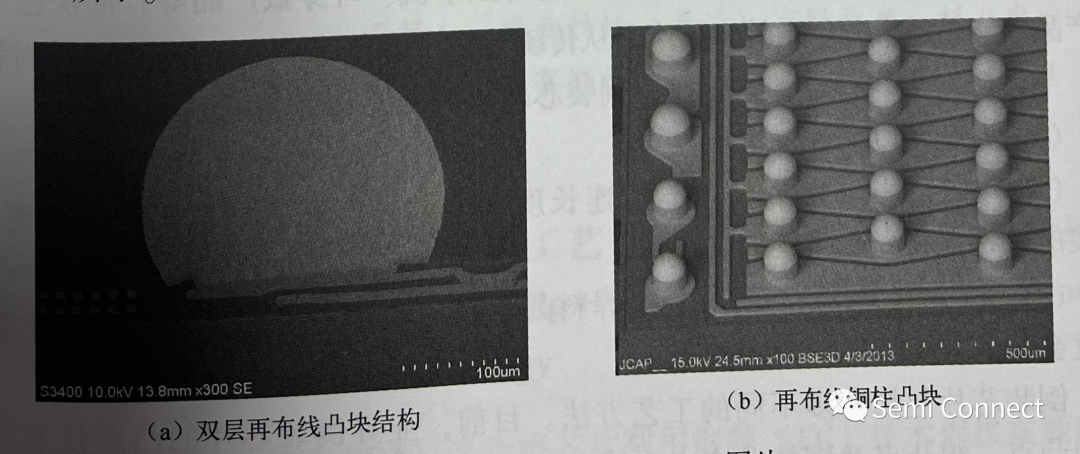
(文章来源:Semi Connect )
![]()