Molding(塑封):
通过模具并在压力和温度的作用下将裸露的芯片用环氧树脂塑封料封装保护起来,为芯片与其它电子元器件提供互联。简单说就是给芯片加一个外壳。
潮湿气、离子污染、热、辐射及机械应力都易引起电子器件性能退化,甚至让其失效。因此,需对电子器件进行封装保护使其免受在加工过程及使用环境中的影响。
塑封前后对比:
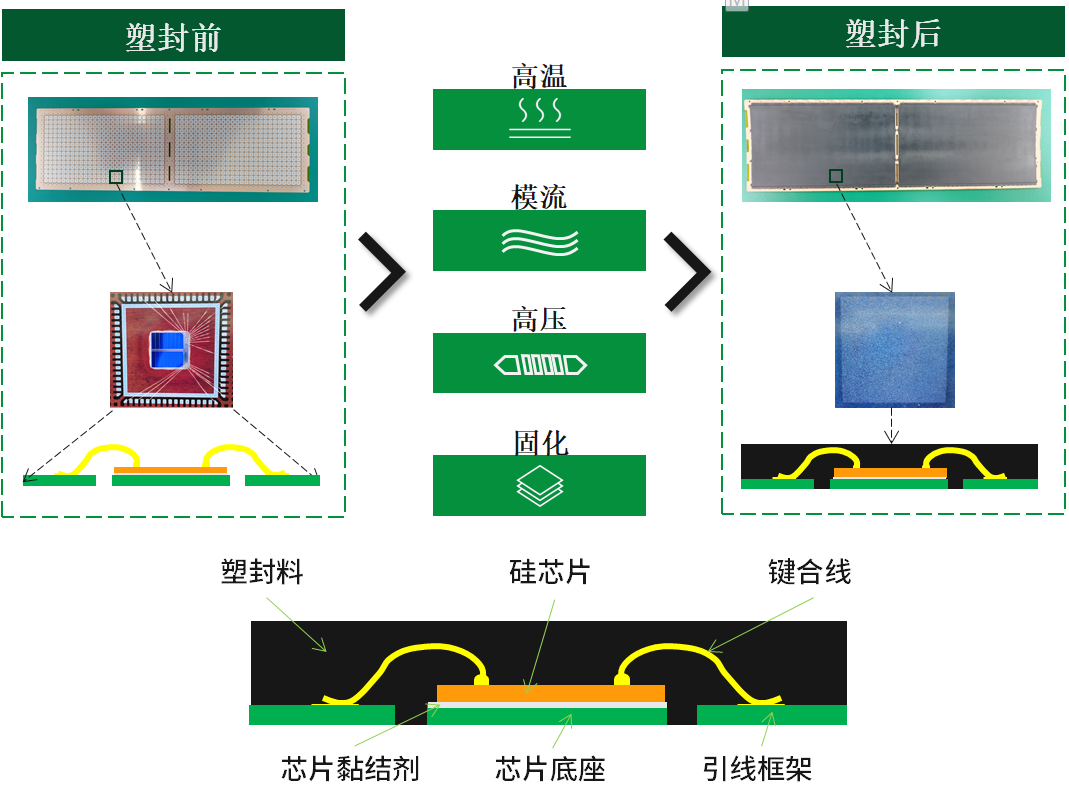
环氧树脂塑封料:

塑封的作用:

塑封过程:
1.将带有芯片的框架放置在下模表面;
2.将环氧塑封料放进胶口;
3.下模向上动作到一定位置并施加压力;
4.注塑杆将受高温融化的环氧塑封料挤压进成型腔体;
5.待一定时间后,产品固化成型完成塑封。
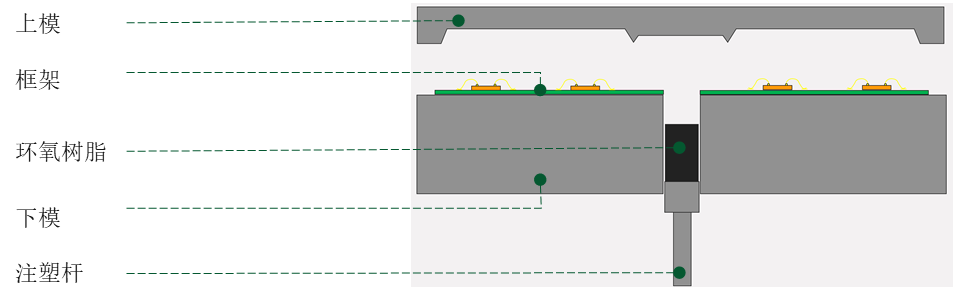
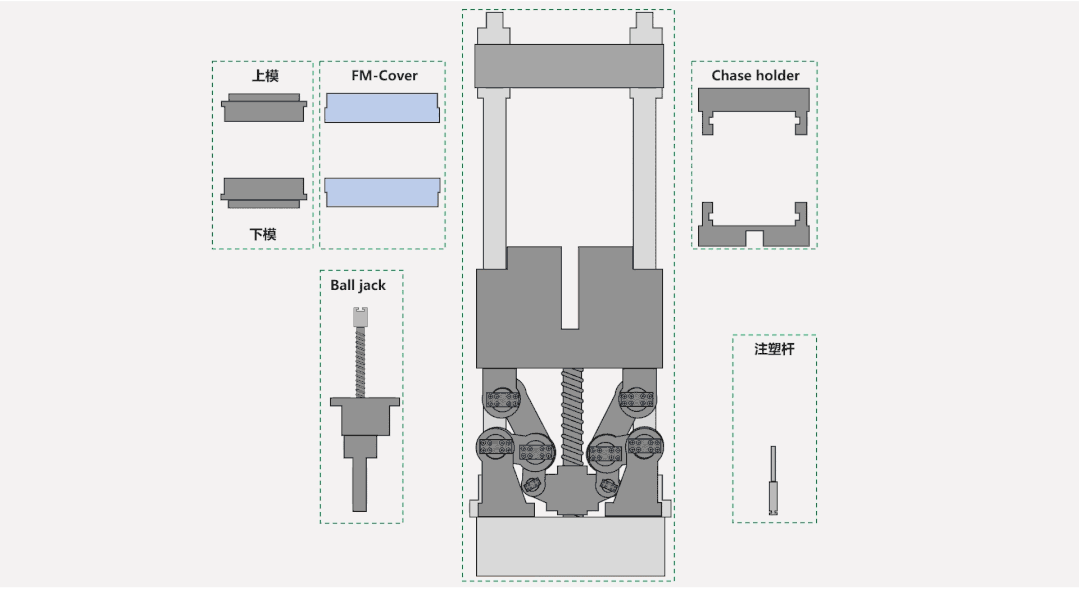
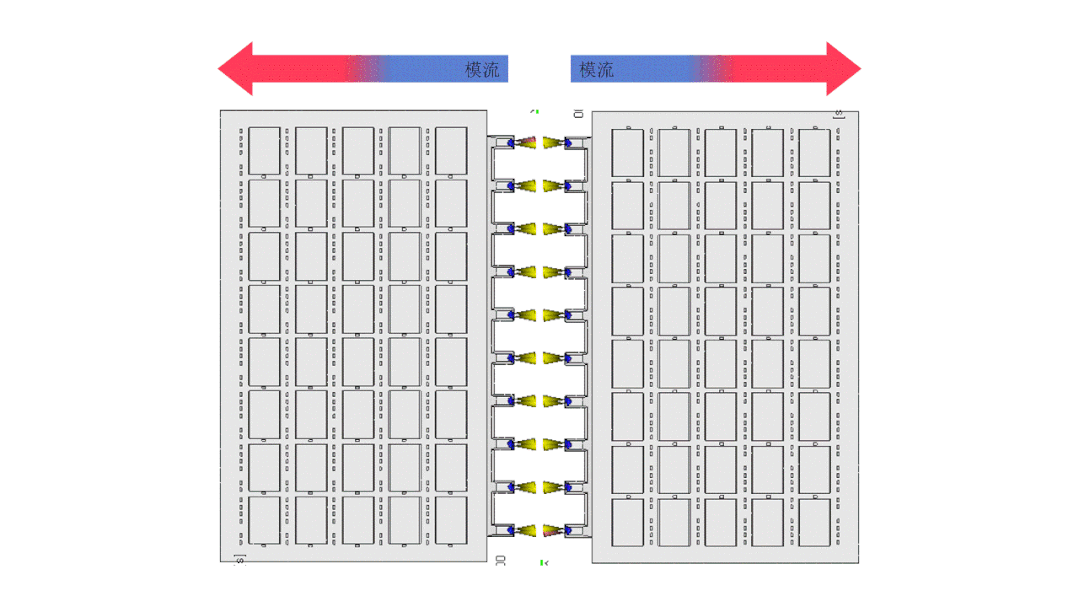
季丰自动塑封机 :TOWA-YPM1180
设备能力:
可进行大尺寸产品的注塑成形封装设备
可对应100mm X 300mm的大型基板
中心加压方式(采用框架结构)
合模能力达180吨,可成形大型框架
独特的小型·高精密压机构造
配有柱塞部集尘系统,提高生产稳定性
可应对QFN、BGA、SOP、QFP、LQFP等系列产品
(文章来源:季丰电子)
![]()