跳至内容
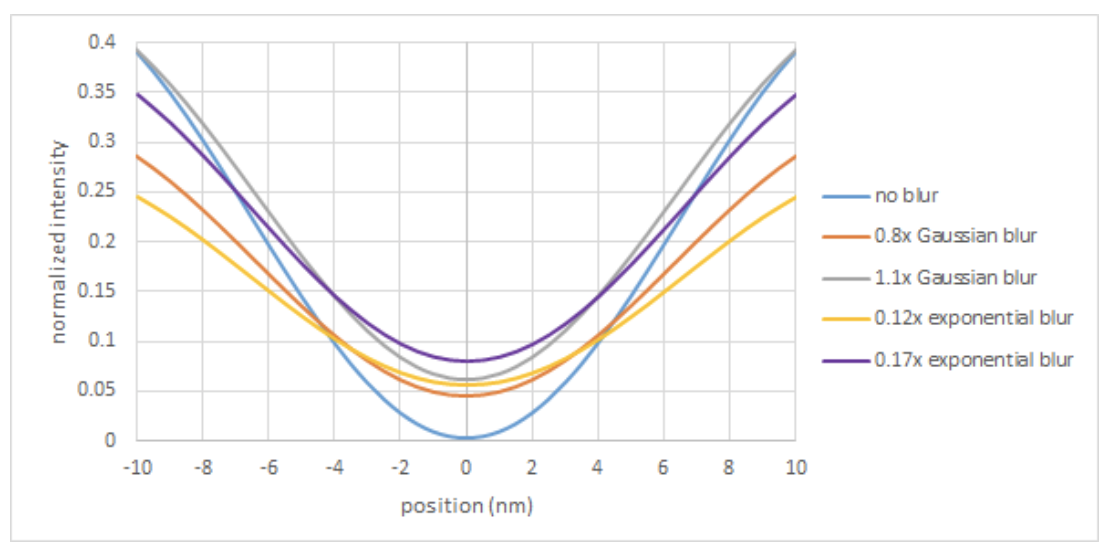 最近消息透露,台积电的 N5 节点的最小栅极间距为 51 nm [,沟道长度小至 6 nm 。如此紧凑的沟道长度需要在图案化过程中严格控制 CD,远低于 0.5 nm。可能的光刻方案有哪些?
最近消息透露,台积电的 N5 节点的最小栅极间距为 51 nm [,沟道长度小至 6 nm 。如此紧凑的沟道长度需要在图案化过程中严格控制 CD,远低于 0.5 nm。可能的光刻方案有哪些?
最先进的 EUV 系统对于 51 nm 间距的选择有限。假设使用亚分辨率辅助特征(SRAF,一个理想的二值图像投影具有良好的 NILS(归一化图像对数斜率)和焦深;然而,模糊破坏了这一结果(图 1)。强度调制因模糊而减弱。
图 1.模糊对 0.33 NA EUV 系统上 51 nm 间距图像的影响。高斯或指数模糊函数与无模糊图像卷积。这里只给出了相对模糊幅度。
不能期望模糊本身具有固定的量级,因为二次电子产率本身就是一个可变量 。仅此一项就产生了大量可能的 CD。此外,电子模糊在本质上比高斯模糊更具指数性。这进一步恶化了影响,因为指数模糊累积了更多来自远离所考虑点的电子的贡献(图 2)。
图 2. 指数与高斯模糊。指数模糊在较短距离处衰减得更快,而高斯模糊在较远距离处衰减得更快。
因此,随着 CD 变化很容易接近甚至超过 50%,EUV 曝光对于栅极图案化来说是不安全的,这需要公差<10%。High-NA 也有同样的问题。即使 NA 高达 1.0 的真空极限(图 3),图像仍然是模糊而不是波长/NA。
图 3. 即使最大 EUV NA 为 1.0,模糊也会降低理想图像的质量。
如果栅极 CD 不是由光刻直接决定,而是由侧壁间隔宽度决定,则情况将完全改变。用于间隔图案化的光刻间距加倍至 102 nm,这很容易被 ArF 浸没式光刻适应。这种自对准双图案 (SADP) 方法已经存在了很长时间。因此,这种栅极图案化方法可能永远不会消失。

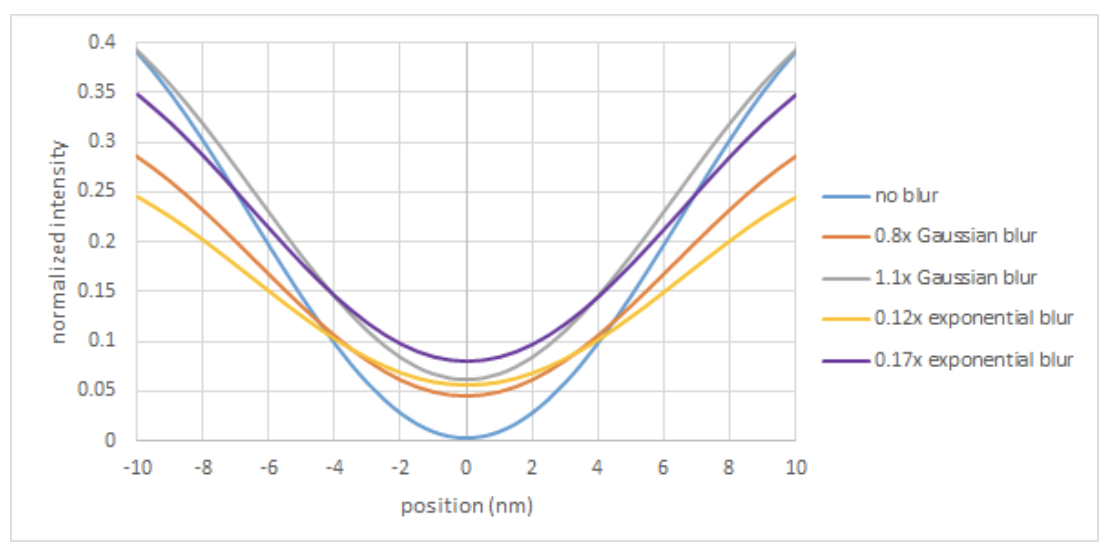

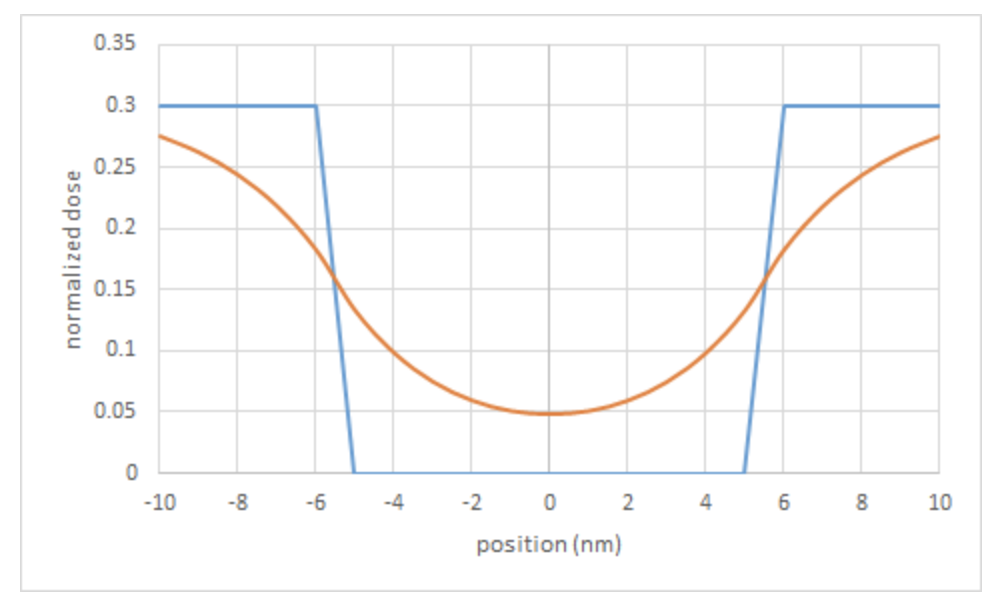
![]()
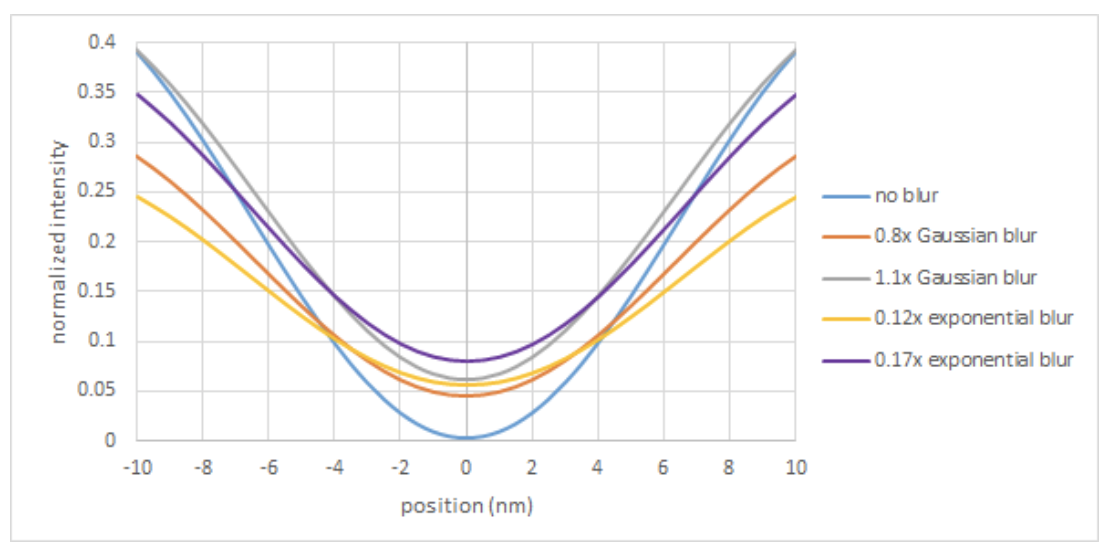
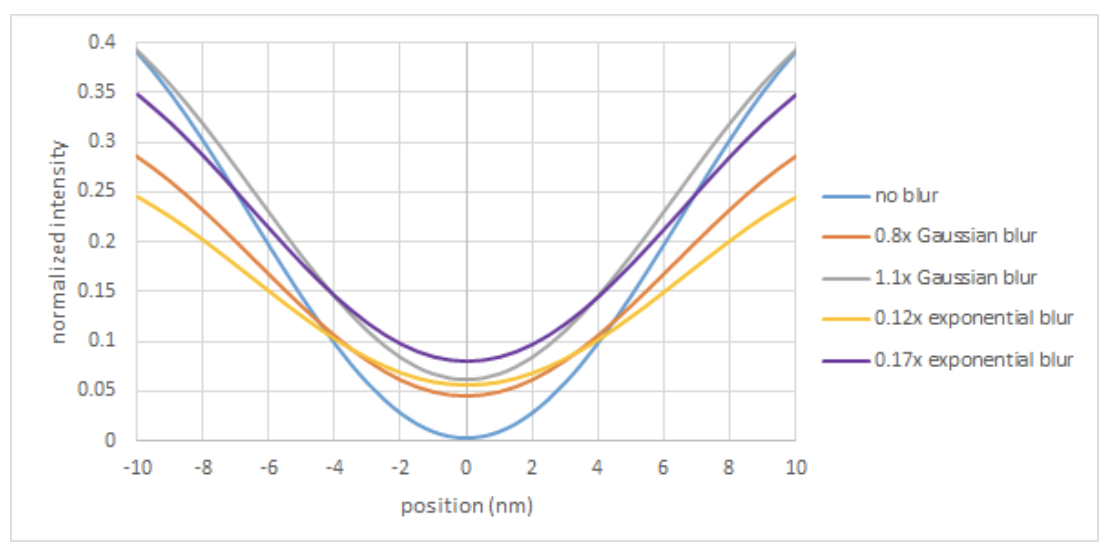

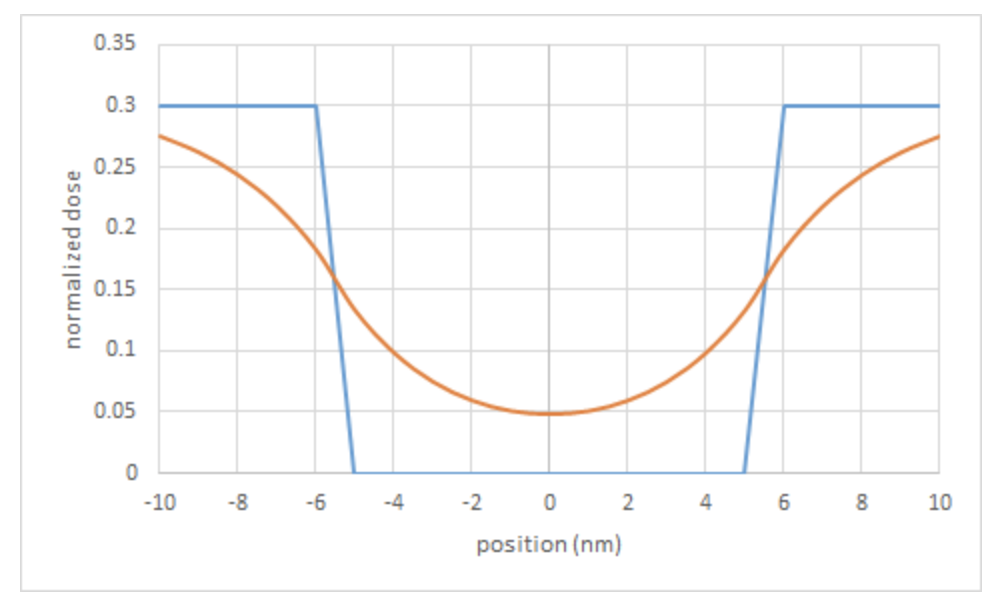
![]()