引言
椭偏光谱(SE)、原子力显微镜(AFM)、X射线光电子能谱(XPS)、润湿性和光致发光(PL)测量研究了HF水 溶液中化学清洗的GaP(OOl)表面。SE数据清楚地表明,溶液在浸入样品后(W1分钟)会立即去除自然氧化 膜。然而,SE数据表明,自然氧化膜不能被完全蚀刻去除。这是因为蚀刻后的样品一暴露在空气中,氧化 物就开始重新生长。SE估计粗糙度约为1纳米,而原子力显微镜粗糙度值约为0.3纳米。XPS光谱证实了自- 然氧化物的去除以及HF蚀刻的GaP表面上再生长氧化物的存在。润湿性测量表明,经氢氟酸清洗的表面是 疏水性的,这与经碱清洗的表面(亲水性)形成直接对比。价格指数略有上升。在HF水溶液中蚀刻后,强度 也提高了。2007年美国物理研究所。
介绍
HF蚀刻导致的形态学变化,这些变化进入我们使用SE数据的光学 建模。
磷化镣(GaP)因其在光电和高温电子传输器件中的应用而成为 最重要的xiii-V半导体之一。
由于其高反应性,GaP表面在室温空气中容易氧化,形成几纳米 厚的天然氧化膜。清洁的材料表面对于各种半导体器件技术来说 是绝对必要的。
有几种表面清洁技术可用于
其中,化学清洗是最简单和最容易控制的,已被广泛 应用于 GaAs2-13 磷化锢、这些研究中使用的主要是酸性物质(HCU HF、H2SO2/H2O2等) 。)和碱性(氢氧化钾、NH2OH等)。)解决方案。
为湿化学清洗的参考资料提供了一个有用的指南 在iii-v族半导体上完成的工作。然而,关于GaP表面清洗的文献 仍然有限17, 18o
仅发表了关于在酸性(HCI)中化学清洗GaP表面的报告(参考文献 o 17)和碱性(氢氧化钾。裁判。18)解决方案。迄今为止,尚未在酸性氢氟酸溶液中进行清 洗研究。在硅技术中,众所周知,高频清洗司以去除 天然氧化物,留下稳定的硅表面,由原子氢终止。
在这篇文章中「我们3艮道了用椭偏光谱(SE)、离位原子力显 微镜(AFM)、x射线光电子能谱(XPS)研究了HF溶液中表 面的化学清洗效应。润湿性和光致发光光谱。硒是一种高度表面 敏感的技术,不仅能检测吸附物质对表面的亚纳米覆盖,还能检 测其尺寸小于光波长的表面粗糙度。20原子力显微镜用于独立评本研究中使用的GaP样品是电阻率约为0.15 Q・cm的n型晶片。样品首先在超声波浴中用有机溶剂脱脂, 然后用去离子水冲洗。没有对样品表面进行进一步清洁。然后, 待研究的样品表面被约2纳米厚的天然氧化膜覆盖。请注意,该值 由SE决定,因此由有效厚度决定。
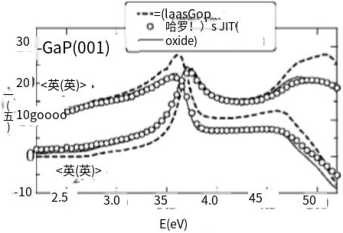
图1在(a) 1重量%中处理的GaP(OOl)的伪介电函数< 8(E))=(si(E))+l(g( E))的实数[(el(E))]和虚数[(E2(E))]部分,以及
(b)t=O(脱脂)和1分钟的50 wt % HF溶液,以及清洁裸露GaP(粗实线)的 溶液。垂直箭头表示每个临界点(E0、El、E%和E2)的位置
实验
图1显示了在(a) 1 wt %和(切50 wt % HF溶液中处理1分钟的GaP( 001)表面的假介电函数光谱。连同从接收样本(=0 s)获得的数据。为了 比较,光谱(s(E))为干净的。
积极地。由于没有关于天然GaP氧化物光学常数的实验数据,我们使用 了在稀释的正磷酸/磷酸电解液中形成的阳极GaP氧化物的介电常数。22
图2中的实线表示三层模型的分析结果,其中天然氧化物作为脱脂、 样品的覆盖层。测量的SE数据由空心圆绘制。虚线还显示了干净、近乎 陡峭的GaP表面的< e(E)>光谱。 –
6=0.020.的
在图3(a)中用实线示出了在1 wt % HF溶液中处理t=l分钟的样品的| 三层分析结果。实验SE (e(E)>数据用空心圆圈标出。分析得出dox=l.. 00 nm的表观GaP氧化膜厚度,无偏估计量为在0度。

图3
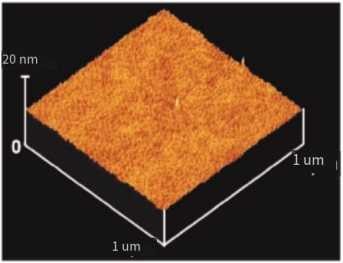
图5。(彩色在线)大面积(1×1卩m2)自动聚焦显微镜图像,从在Iwt%氟化氢溶液 中处理1分钟的样品获得。从该图像获得的均方根粗糙度约为0.3纳米。
结论
在盐酸蚀刻GaP(lll)al7的情况下,在盐酸处理后观察到光致发 光强度的大幅度降低;即1.65电子伏的光致发光峰值强度通过盐酸 蚀刻降低到约20%0表面复合速度是表征表面所需的唯一参数。
![]()