氮化镓作为一种宽带隙半导体,已被用于制造发光二极管和激光二极管等光电器件。最近已经开发了几种用于氮化镓基材料的不同干蚀刻技术。电感耦合等离子体刻蚀因其优越的等离子体均匀性和强可控性而备受关注。本研究采用电感耦合等离子体刻蚀法对氮化镓基发光二极管结构进行干法刻蚀,刻蚀气体为氯气,添加气体为三氯化硼。研究了刻蚀气体流量、电感耦合等离子体功率、射频功率和室压等关键工艺参数对氮化镓基发光二极管结构刻蚀性能的影响,包括刻蚀速率、选择性、刻蚀表面形貌和侧壁。使用深度轮廓仪测量蚀刻深度,并用于计算蚀刻速率。用扫描电子显微镜观察蚀刻剖面。
结果和讨论
图1显示了在1000瓦的电感耦合等离子体功率、100瓦的射频功率和7托的室压下,样品的蚀刻速率和对二氧化硅的蚀刻选择性。从图1可以看出,蚀刻速率随着三氯化硼的增加而降低,蚀刻选择性也随着气体混合物中三氯化硼百分比的增加而降低。在纯Cl2气体中获得的最高蚀刻速率约为262纳米/分钟。当在纯Cl2气体中加入三氯化硼时,蚀刻选择性迅速降低,在100% Cl2中,选择性高达约66左右。

图1 在1000WICP功率、100W射频功率和7mtorr腔室压力下,缺口速率和选择性作为氯气/三氯化硼气体比的函数
图2显示了在ICP功率1000W、20%BCl3/80%Cl2和射频功率100W时,腔室压力对蚀刻速率和选择性的影响。蚀刻速率随着压力的增加而增大,达到最大值,然后随着腔室压力的进一步增加而减小。在10mtorr的腔室压力下获得的最高蚀刻速率约为253nm/min。蚀刻选择性随腔室压力的增加而单调增加。

图2 在20%三氯化硼、1000WICP功率和100W射频功率下,切口率和选择性作为腔室压力的函数
一些蚀刻剖面图如图3所示。可以看出,不同的蚀刻参数影响了侧壁的形态。气体混合物中三氯化硼%的增加降低了蚀刻的各向异性。ICP功率对蚀刻各向异性的影响并不明显。更高的射频功率可以导致更垂直的侧壁。
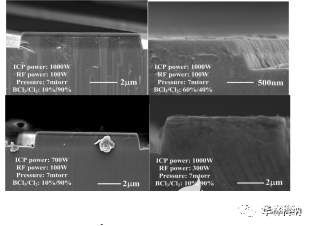
图3 具有不同蚀刻参数的一些蚀刻轮廓的扫描电镜照片
结论
综上所述,以氯气为基气体,三氯化硼为添加剂气体,对gan基LED结构进行ICP蚀刻。研究了蚀刻气体比、ICP功率、射频功率和腔室压力等关键工艺参数对Gan基LED结构蚀刻性能的影响。ICP功率为1000W时,蚀刻速率为717nm/min20%BCI3/80%CI2,射频功率500W,腔室压力7mtorr。本文还对不同蚀刻参数下的蚀刻侧壁形态进行了研究。可以看出,气体组合对蚀刻各向异性的影响很大。
![]()