溶液中晶片表面的颗粒沉积。然而,粒子沉积和清除机制液体。在高离子中观察到最大的粒子沉积:本文将讨论粒子沉积的机理酸性溶液的浓度,并随着溶液pH值的增加而降低,在使用折痕。还研究了各种溶液中的颗粒去除效率。在大约0.05∶1∶5(0.05份nh4oh、1份H2O、5份H2O)的比率下,优化了nh4oh-1-zO溶液中的nh4oh-1∶5的IH含量。在使用该比率的NHdOH-hzo tFt处理期间,通过表面微观粗糙度测量的损伤没有增加。
介绍
QT清洗技术将继续在半导体器件的ULSI制造中发挥重要作用。随着ULSI器件图案密度的增加,需要湿法清洗工艺来去除越来越多的小颗粒,以便获得更高的器件成品率和增强电路可靠性。为了尽量减少半导体晶片表面的微粒污染,有必要了解微粒沉积和去除的机理。诸如溶液中颗粒的数量、这些颗粒的ζ电势和晶片表面的电势等因素都是颗粒沉积和去除的重要因素。
结果与讨论
A. 晶片表面上的颗粒沉积
在高酸性溶液中观察到;它随着溶液pH值的增加而降低。 显示了众所周知的pH值对FetO颗粒ζ电位的影响。可以看出,图1和图2的曲线几乎完全匹配。由于颗粒的ζ电势取决于溶液的pH值,因此溶液的pH值是决定颗粒在晶片表面沉积的最重要因素之一。
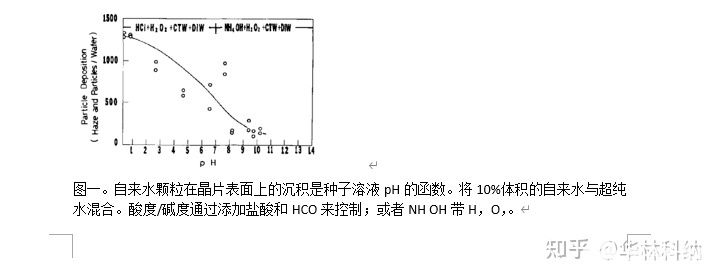

随着超大规模集成电路器件图形密度的增加,为了获得更高的器件成品率和提高电路的可靠性,需要在不增加表面微观粗糙度的情况下,采用湿法清洗工艺从硅片表面去除更多更小的颗粒。
对于溶液中的粒子沉积机制,半导体晶片表面的行为可以用胶体科学的充分证明的原理来描述。首先,晶片表面的污染水平与工艺流体的离子强度有关。这意味着低离子强度和特定浓度的超纯水对于湿法清洗过程是必不可少的。第二,在高离子强度酸性溶液中观察到最大颗粒沉积,并随着溶液pH值的变化而减少。酸性溶液中的颗粒浓度必须尽可能低。此外,碱性溶液必须足以从晶片表面去除颗粒。
为了在不增加表面微观粗糙度的情况下建立无颗粒的晶片表面,使用减少NH4 H含量的NH4OH-H2O,H2溶液研究了颗粒去除效率。结果,我们发现颗粒去除效率是很高的
针对大约0.05 : 1 : 5的N H、OH含量优化(0.05份NH、OH、1份HCO、5份H2O)。这意味着NH4OH含量可以降低到传统浓度的5 %,同时仍然保持高的颗粒去除效率,并且不增加表面微观粗糙度。
![]()