几种设计趋势相结合,显著增加了 IC 测试生成所需的计算资源。首先是设计规模和复杂性的增长。与此同时,可用于 2D 封装测试访问的 I/O 更少了。
这些因素也导致测试覆盖率、良率、功耗和互连测试要求承受巨大压力。3D 裸片堆叠和封装是改进系统级封装技术的重要一步。3D 裸片堆叠有多种方法,但它们的共同目标是使用尺寸更小且良率高的裸片进行垂直堆叠。这种策略缓解了大型 2D 或 2.5D 器件的许多测试挑战。
在对 3D 堆叠中组装的裸片进行晶圆探针测试时,建议采用高质量的已知良好裸片 (KGD) 测试。KGD 测试通常包括除裸片间互连测试以外的所有封装测试。
然后,封装测试需要进行裸片间 (D2D) 互连测试并重新运行 KGD 测试,以确保封装和组装期间没有引入任何缺陷。每个级别的 3D 测试都需要进行故障诊断,包括完整的封装级堆叠层诊断。
在本文中,我们详细介绍了一种灵活可扩展、易于实现且全面的 3D IC DFT 解决方案。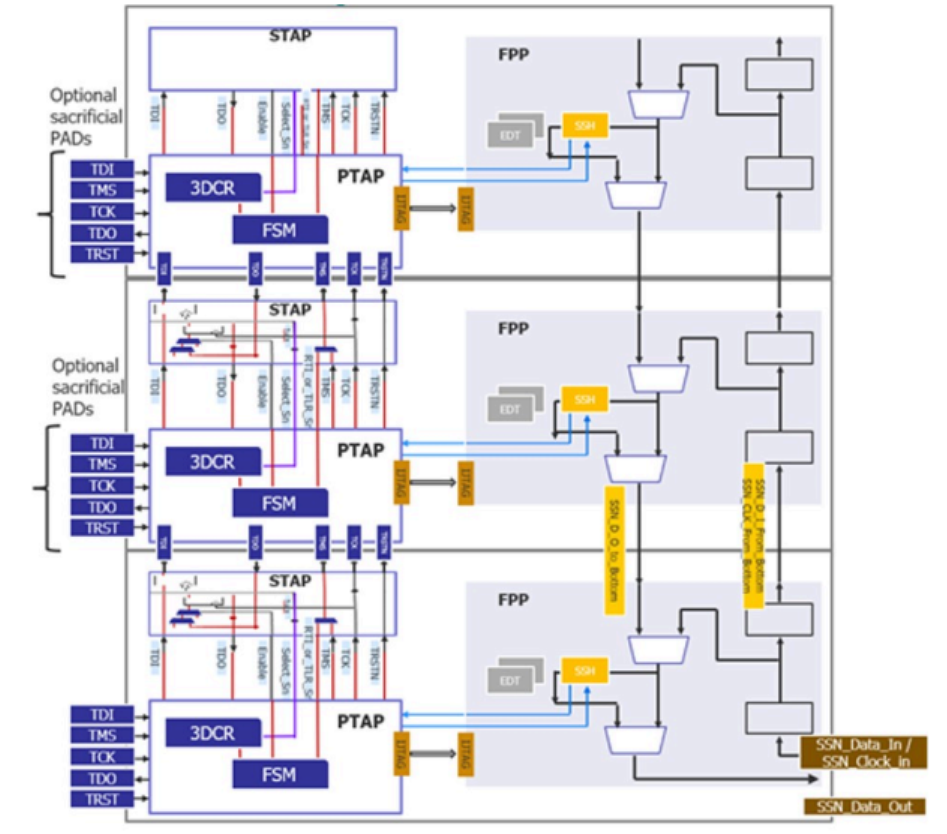
图 1:Tessent 3D DFT 解决方案概述
(文章来源:西门子EDA)
![]()