封装技术发展历程
封装技术的发展需要满足电子产品小型化、轻量化、高性能等需求,因此,封装朝小型化、多引脚、高集成目标持续演进。
封装有多种分类方法:
1) 按材料可以划分为:金属封装、陶瓷封装、塑料封装等;
2) 按照和PCB板连接方式分为: PTH封装、SMT封装 ;
3) 按照封装外型可分为: SOT、SOIC、TSSOP、QFN、QFP、BGA、CSP 等。
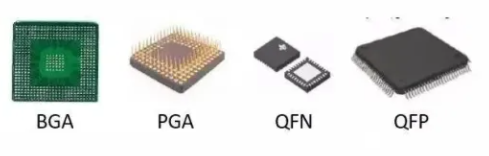
目前封装历史主要按封装技(是否焊线)将封装工艺分为传统封装与先进封装。传统封装的基本连接系统主要采用引线键合工艺,先进封装指主要以凸点(Bumping)方式实现电气连接的多种封装方式,旨在实现更多 I/O 、更加集成两大功能。
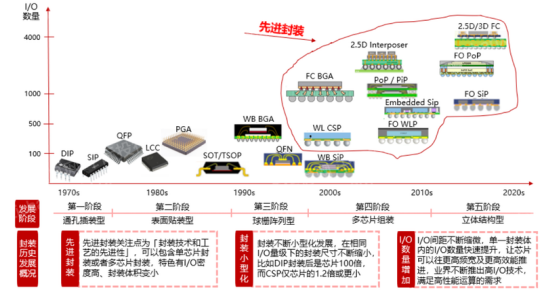
▲资料来源:资产信息网 千际投行 Yole 封装历史发展大概分为五阶段,当前,全球封装行业的主流技术处于以 CSP、BGA 为主的第三阶段,并向以系统级封装(SiP)、倒装焊封装(FC)、芯片上制作凸点 (Bumping)为代表的第四阶段和第五阶段封装技术迈进。

▲资料来源:资产信息网 千际投行 Yole 传统封装与先进封装间并不存在绝对的优劣之分与替代关系,下游应用端对高算力、集成化的需求提升致使先进封装技术成为未来发展趋势。 先进封装形式发展 先进封装技术的发展趋势可以分解为3个分向量: (1)功能多样化:封装对象从最初的单裸片向多裸片发展,一个封装下可能有多种不同功能的裸片; (2)连接多样化:封装下的内部互连技术不断多样化,从凸块(Bumping)到嵌入式互连,连接的密度不断提升; (3)堆叠多样化:器件排列已经从平面逐渐走向立体,通过组合不同的互连方式构建丰富的堆叠拓扑。先进封装技术的发展延伸和拓展了封装的概念,从晶圆到系统均可用“封装”描述集成化的处理工艺。
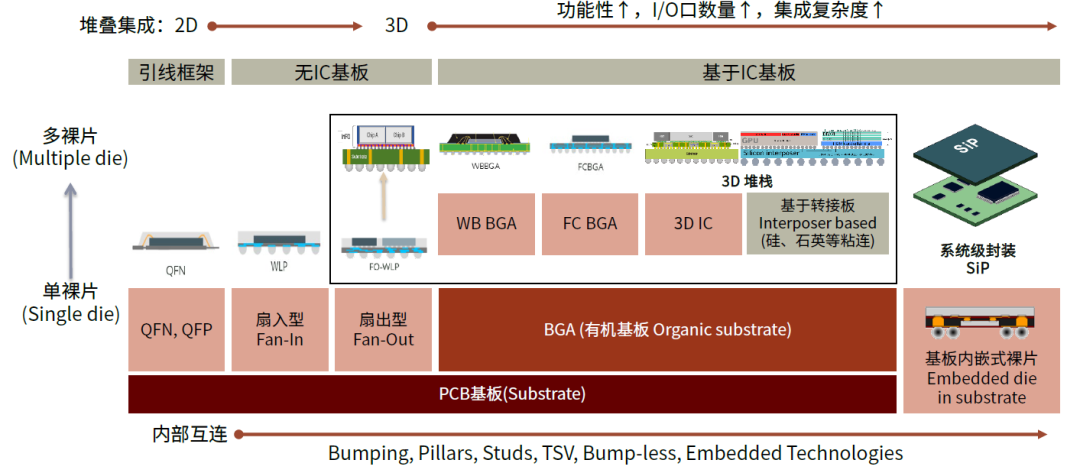
▲资料来源:资产信息网 千际投行 Yole 半导体产品在由二维向三维发展,从技术发展方向半导体产品出现了系统级封装(SiP)等新的封装方式,从技术实现方法出现了倒装、凸块、晶圆级封装、2.5D封装、3D封装(TSV)等先进封装技术。
主流先进封装形式介绍
WLP(晶圆级封装)
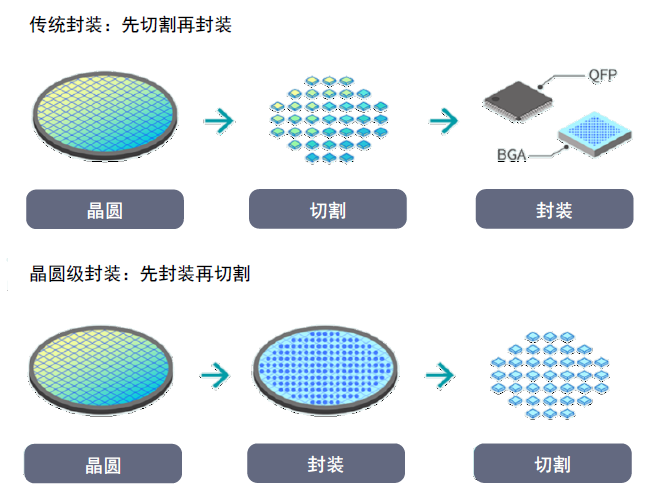
▲资料来源:SK Hynix,中金公司研究部 3D IC(立体封装)
3D IC的初期型态是在封装级别依靠传统互连方法(键合/倒装)实现垂直堆叠。与2.5D不同的是,3D通常含有芯片或器件之间的堆叠。
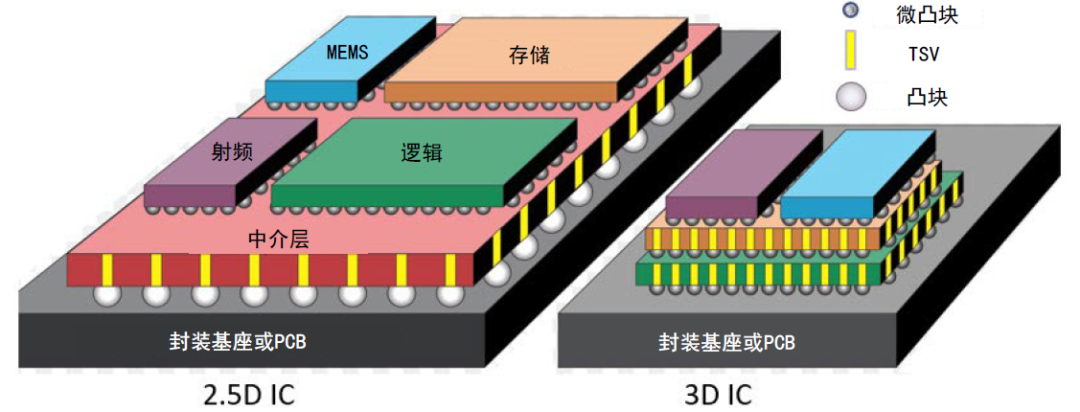
▲资料来源:Semiconductor Engineering,中金公司研究部 SiP(系统级封装)
SiP是将多个具有不同功能的有源电子元件(通常是裸芯片)、无源器件及其他器件(MEMS或光学器件等)构成一个系统或子系统,并将多个系统组装到一个封装体内部,使其成为一个可以实现一定功能的单体封装件。从连接方式上看,倒装、扇出型和嵌入式(Embedded Die)是实现SiP的三条常见技术路线。

▲资料来源:Yole Development,中金公司研究部 Chiplet(芯粒)
Chiplet是将单颗SOC芯片的各功能区分解成多颗独立的芯片,并通过封装重新组成一个完整的系统。
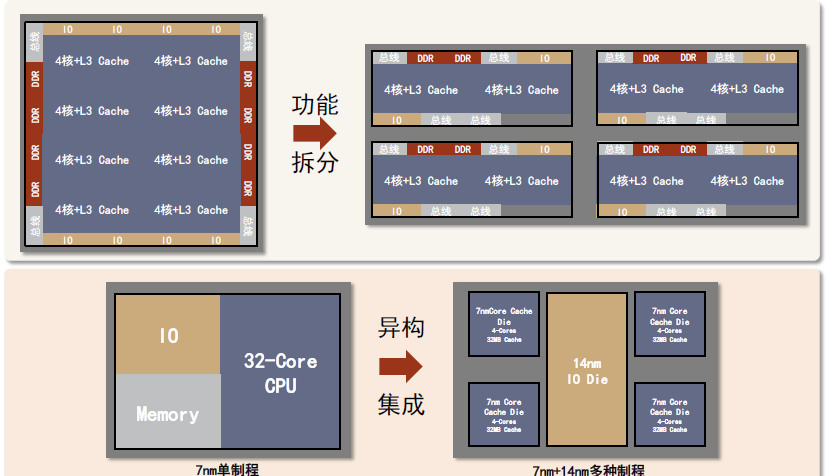
▲资料来源:AMD官网,中金公司研究部 先进封装发展趋势与竞争格局
1、集成电路进入“后摩尔时代”,先进封装作用突显
“后摩尔时代”制程技术突破难度较大,工艺制程受成本大幅增长和技术壁垒等因素上升改进速度放缓。由于集成电路制程工艺短期内难以突破,通过先进封装技术提升芯片整体性能成为了集成电路行业技术发展趋势。 2、先进封装将成为未来封测市场的主要增长点 在芯片制程技术进入“后摩尔时代”后,先进封装在高端逻辑芯片、存储器、射频芯片、图像处理芯片、触控芯片等领域均得到了广泛应用。 根据市场调研机构Yole预测数据,全球先进封装在集成电路封测市场中所占份额将持续增加。与此同时,Yole 预测2019年至2025年全球传统封装年均复合增长率仅为1.9%,增速远低于先进封装。

▲图源:Yole 3、系统级封装(SiP)是先进封装市场增长的重要动力
系统级封装产品灵活度大,研发成本和周期远低于复杂程度相同的单芯片系统(SoC)。 根据市场调研机构 Yole 统计数据,2019年全球系统级封装规模为134亿美元,占全球整个封测市场的份额为23.76%,并预测到2025年全球系统级封装规模将达到188亿美元,年均复合增长率为 5.81%。

▲图源:Yole
在系统级封装市场中,倒装/焊线类系统级封装占比最高,2019年倒装/焊线类系统级封装产品市场规模为122.39亿美元,占整个系统级封装市场的91.05%。根据Yole预测数据,2025年倒装/焊线类系统级封装仍是系统级封装主流产品,市场规模将增至171.77亿美元。 根据Yole预测,未来5年,系统级封装增长最快的应用市场将是可穿戴设备、Wi-Fi路由器、IoT物联网设施以及电信基础设施。

▲图源:Yole
4、高密度细间距凸点倒装产品(FC)类产品在移动和消费市场发展空间较大
据Yole数据,2020年至2026年,先进封装收入预计将以7.9%的复合年增长率增长。到2026年,FC-CSP(倒装芯片尺寸封装)细分市场将达到100亿美元以上。 按收入细分,移动和消费市场占2019年先进封装总收入的85%, Yole预计到2025年复合年增长率为5.5%,占先进封装总收入的80%。而FC CSP 封装在移动和消费市场中占有一席之地,主要用于PC、服务器和汽车应用中使用的智能手机APU、RF组件和DRAM设备。
5、扁平无引脚封装产品(QFN/DFN)产品仍拥有较大容量的市场规模
QFN/DFN封装形式虽属于中端封装类型,但市场容量较大,短期内被替代的可能性较低。QFN/DFN类产品有以下优点: (1)物理层面:体积小、重量轻、效率高。 (2)品质层面:散热性能强、电性能好、可靠性强。 (3)具备更高的性价比
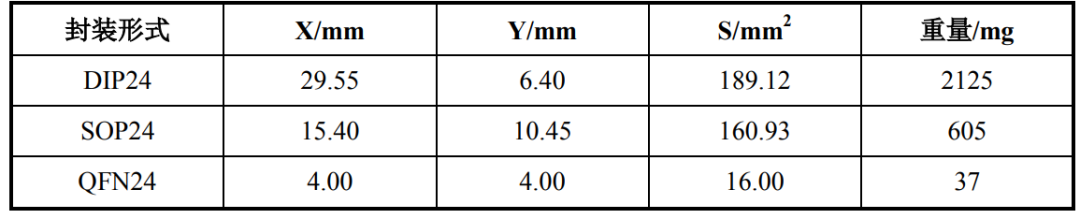
随着集成电路产业的转型升级、政策及资金支持,消费电子产业的快速崛起都推动了先进封装的市场发展,吸引了全球各大主流IC封测厂商在先进封装领域进行持续布局。
1、全球集成电路封装市场竞争格局:日月光和三星电子两雄争霸
在集成电路封装领域,日月光和三星电子为全球龙头企业。日月光是首先量产SiP封装的公司之一,很多可穿戴芯片方案选择日月光的SiP服务。日月光也提供全面的半导体测试服务,包括前端工程测试、晶圆探测、逻辑/混合信号/ RF /(2.5D / 3D)模块、SiP / MEMS的最终测试以及其他测试相关服务。三星电子作为老牌集成电路巨头,具有从设计、制造到封装的全产业链布局,其研发方向主要为先进封装。

▲图源:前瞻产业研究院
2、中国集成电路封装行业竞争格局:可分为三大竞争梯队
我国的集成电路封装市场较为集中,市场竞争较为激烈。目前,我国液晶集成电路封装市场的主要参与者有长电科技、通富微电、华天科技等企业,位于竞争第一梯队的有长电科技、通富微电、华天科技,三者跻身2020年全球前十大封测厂商;第二梯队有晶方科技、太极实业等企业,其规模较第一梯队有所差距;其他中低端封装制造商处于竞争第三梯队。

▲图源:前瞻产业研究院
从我国集成电路封装产业链企业区域分布来看,集成电路封装产业企业主要分布在江苏、浙江、上海等沿海省市,其中江苏省集成电路封测企业数量最多。同时,内陆省份分布较为分散,主要集中在甘肃省、湖南省两地。

▲图源:前瞻产业研究院
从代表性企业分布情况来看,以江苏为总部的江苏长电科技股份有限公司、通富微电子股份有限公司、苏州晶方半导体科技股份有限公司;以甘肃为中心的天水华天科技股份有限公司知名度较高。

先进封装设备走向国产化乘着先进封装发展的东风,先进封装设备也逐步走向国产化,国内封装设备市场进一步发展。
封测设备可分为封装设备及测试设备两大类。封装设备方面,与引线键合工艺中背面减薄晶圆切割、贴片、引线键合、模塑密封、切筋成型六大工序相对应,传统封装设备按工艺流程主要分为减薄机、切割机、贴片机、引线键合机、塑封机及切筋成型机。 在以凸点焊(Bumping) 代替引线键合的先进封装工艺中,还需用到倒装机、植球机、回流炉等设备例如硅通孔 (TSV) 等,先进封装工艺中也会用到光刻机、刻蚀机、电镀机、PVD、CVD 等半导体制造前道设备。 测试过程贯穿半导体制造的全工艺流程,主要分为设计验证测试、过程控制测试、晶圆检测 (CP,Circuit Probing)、成品测试 (FT,Final Test),其中CP测试及FT测试发生在晶圆制造后,属于半导体制造后道检测,主要测试设备为测试机、探针台、分选机。CF测试主要用到测试机、探针机;FT 测试主要用到测试机、分选机。 过程控制测试为晶圆制造全过程的检测,主要用到光学显微镜、缺陷观测设备等;设计验证测试由于对芯片样片的全流程检测,故需使用上述全部半导体测试设备。

▲图源:华泰研究
机构人士分析指出,先进封装发展将会增加设备需求:①封装设备需求增加:例如研磨设备增加(晶圆需要做的更薄)、切割设备需求增加、固晶设备增加(DieBond要求更高);②新设备需求:如凸块(bump)工艺涉及到曝光、回流焊等设备等。

▲图源:华西证券研究所
全球封装设备呈现寡头垄断格局,ASM Pacific、K&S、Besi、Disco、Towa、Yamada等公司占据多数的封装设备市场,行业本土替代空间大。 Tensun腾盛专注高端精密装备,深度掌握精密点胶、精密划片、精密运控平台等核心技术;对标世界级品质标准,获得行业多项资质、专利及荣誉。Tensun腾盛始终坚持技术创新,点胶设备成为市场主选,今年Jig Saw全自动分选一体机正式量产出货,进一步推动先进封装市场发货量,推进半导体封测设备国产化进程!
(文章来源:DT半导体)
![]()