半导体装置为了达成附加值高的系统LSI,需要高集成化,高速化,这其中新的布线材料,绝缘膜是不可缺少的。其中,具有低电阻的Cu,作为布线材料受到关注。化学机械抛光(CMP)和之后的清洗是Cu布线形成中不可缺少的过程,CMP中使用的浆料、清洗液的性能在很大程度上左右了布线的形成。
在本文中对进行了CMP和后清洗的晶圆表面进行分析表面分析的Cu―CMP工程的评价。
Cu-CMP工序
Cu布线是通过双镶嵌法形成的。双镶嵌法是在一次性制作布线沟和布线孔之后,通过电镀法等嵌入Cu的方法。后清洗液必须除去用CMP削去的Cu和其他成为污染原因的物质,保护裸露的布线Cu。颗粒有泥浆的磨粒,被研磨过的布线Cu和垫的研磨碎屑,离子性杂质有Cu和泥浆中的添加剂产生的络合离子等。以往在去除颗粒时使用氨水,在去除离子性杂质时使用氢氟酸。但是,由于Cu被氨水和氢氟酸腐蚀,所以需要完全不同的清洗液。另外,还要求废液处理容易,对环境的负荷低,作为清洗液,开发了电解离子水、臭氧水和抑制有机酸、Cu腐蚀的碱性清洗液等。
测定方法
在Cu-CMP工艺的确立,浆料,后清洗液的开发中,把握实际工艺中残留在晶圆表面的添加剂和布线Cu的腐蚀是很重要的。在TOF―SIMS中,用Ga离子照射晶圆,通过检测产生的离子,得到存在于极表面的物质的质谱。根据分子量,光谱模式推定化合物(图3)。

防锈剂的评价事例
图6的光谱是TOF-SIMS测定的结果。可以确认BTA存在于Cu膜上。TOF-SIMS中得到的离子,即使是低浓度,也以与高浓度时同样高的强度检测出BTA 。通过用酸进一步清洗用BTA处理后的晶片,来自BTA的片段离子的强度变弱。
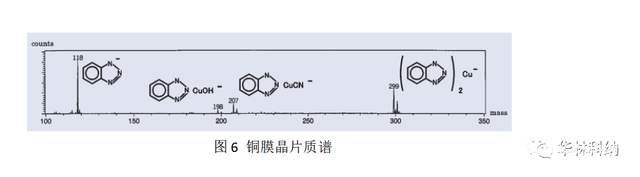
总结
半导体领域CMP工程中使用的浆料、后清洗液中含有各种各样的添加剂,通过复杂的作用进行研磨、平坦化。不仅仅是药液本身的分析,作为程序的开发,通过使用TOF―SIMS,XPS分析,可以认为对处理条件的最优化和能够确保的程序裕度的决定是有效的。
另外,在其他工业领域中,作为添加剂评价和表面状态评价,这种表面分析方法也发挥了威力。
![]()

