提供了一种在单个晶片清洁系统中去除后处理残留物的方法。该方法开始于向设置在衬底上方的邻近头提供第一加热流体。然后,在基板的表面和邻近头的相对表面之间产生第一流体的弯液面。基板在接近头下方线性移动。还提供了单晶片清洁系统。
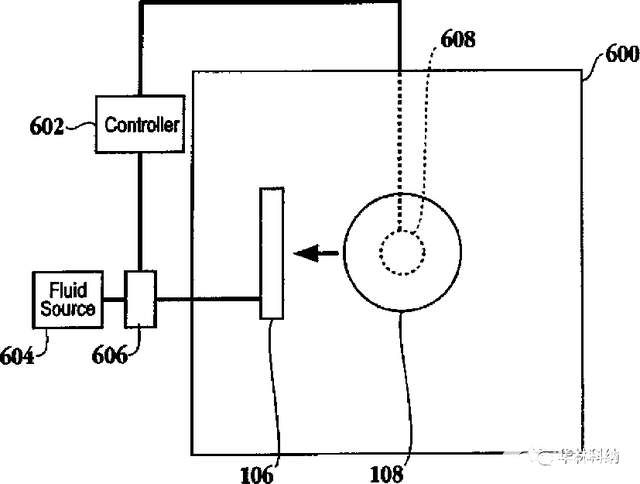
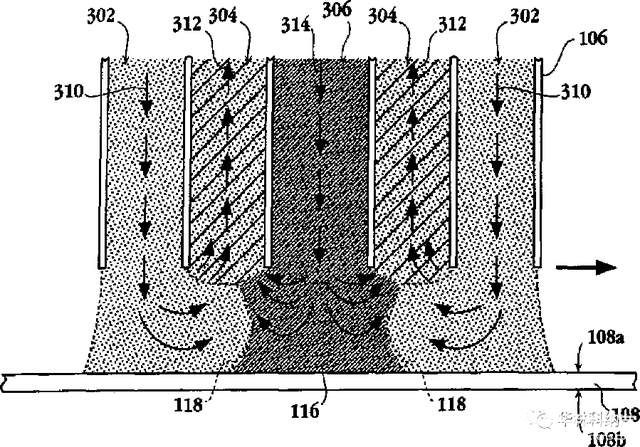
发明领域
本发明涉及半导体晶片15的清洁和干燥,更具体地,涉及在蚀刻或灰化操作之后更有效地从晶片表面去除残留物的装置和技术。
相关技术的描述
在半导体芯片制造工艺中,众所周知需要清洁和干燥晶片,其中已经执行了在晶片表面留下不需要的残留物的制造操作。等离子蚀刻操作和灰化操作可能会在基板表面上留下不需要的残留物。例如,在双 25 次镶嵌后清洗中,在这些操作之后,有机和无机残留物都保留在基板表面上。有机残留物可能是光刻胶的残留物或由反应物有意产生以保护蚀刻 30 工艺期间形成的特征的侧壁,而无机残留物可能是溅射操作的残留物或下部金属互连层的氧化物。如果不去除,多余的残留材料和颗粒可能会导致,除其他外,晶片表面上的缺陷和金属化 35 特征之间的不适当相互作用在某些情况下,此类缺陷可能会导致后续金属互连层在金属线中产生空隙或高电阻,甚至在当前金属层与先前金属层之间的接触界面处产生空隙,从而导致晶圆上的器件无法运行。
![]()