本文研究了金属蚀刻残留物,尤其是钛和钽残留物对等离子体成分和均匀性的影响。通过所谓的漂浮样品的x射线光电子能谱分析来分析室壁,并且通过光发射光谱来监测Cl2、HBr、O2和SF6等离子体中的Cl、Br、O和F的密度,测量300毫米硅片的蚀刻速率来检查等离子体的均匀性,发现氯和溴在金属上的复合概率与在阳极氧化铝上的复合概率相似,然而,氟和氧的复合受到金属残留物的强烈影响,因此,对于基于氟和氧的等离子体,金属残留物显示出对等离子体均匀性有影响。

在蚀刻任何衬底的过程中,蚀刻副产物会沉积在反应器中,如果没有适当的清洁策略,这些沉积物会影响随后的蚀刻过程,为了在实验中模拟这些副产物的沉积,用高偏压功率inCl2 /HBr/O2等离子体蚀刻晶片,图1中分别示出了未经等离子体处理的晶片、SF6 /O2等离子体后的清洁室、涂有SiO2的室、被钛污染的室和被钽污染的室的XPS结果。
实验是在不同压力下进行的,但目的不是比较不同压力下的结果,因为等离子体的电子温度随压力变化,OES结果可能不可靠,因此,当蚀刻室壁改变时,数据反映了物种密度的差异,Cl2和HBr等离子体中Cl和Br密度的结果如图2所示。

从这些图中可以发现,氯和溴在复合方面表现出相似的行为,此外,当金属沉积在腔室中时,Cl和Br物种密度似乎几乎不受影响。在绘制了O2和F6等离子体的相对强度数据中,对于SF6等离子体,没有提供二氧化硅涂覆室的数据,因为氟缓慢蚀刻二氧化硅,所以发射光谱中的强度差异不可能仅与复合有关。当金属如钛和钽沉积在腔壁上时,氧和氟的复合似乎确实发生了显著的变化,当有金属存在时,氟的密度增加,而当有金属污染时,氧的密度降低,这意味着金属沉积物在壁上产生了使氟的复合率减少,并增加了氧的复合率。
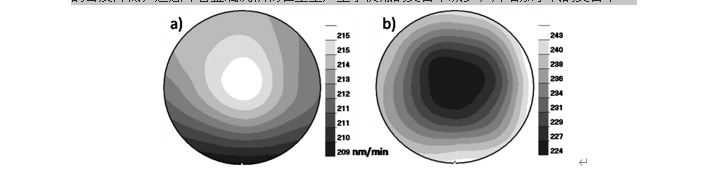
在图4中,显示了清洁和钽污染蚀刻室的六氟化硫等离子体中非晶硅的蚀刻速率,从图4中还可以清楚地看到室壁对等离子体均匀性的影响,在清洁室中,蚀刻速率在中心-高蚀刻速率中较高,而对于钽污染室,可以观察到中心-低蚀刻速率。令人惊讶的是,两个实验的整体均匀性几乎相同。
在O2等离子体中横向蚀刻或修整80 nm光致抗蚀剂线,可以在干净的和被钽污染的室内完成,洁净室中的总微调率要高得多,在这两种情况下,都观察到中间高的修整率,但是在洁净室条件下获得了更好的均匀性,以秒计。
晶片上基团的不均匀性可能源于不同的现象,然而基本上它总是起源于这样一个事实,即自由基在反应器中没有均匀地产生或消失,中性气体被注入反应器的中心,并通过电子碰撞离解而离解,分子也可以通过原子的重组在反应器壁上产生。
因此,中性粒子在等离子体中的均匀性将取决于中性分子从入口或壁注入等离子体的速度,以及原子和分子在等离子体中扩散以补偿浓度梯度的速度,对于质量大、直径大的分子和高压过程,扩散较慢,因此,低压过程应该具有最均匀的中性分布,当需要高气流时,这必然会导致中心低的蚀刻速率分布,尤其是含有重分子的气体,如SF6。气体以高速射向晶片,不会因扩散而分解或混合,这个问题的解决方案是调节气体的注入,例如,通过在反应器的边缘注入一部分气体。
对于钽污染室中的SF6等离子体,观察到中心低的蚀刻速率,从标准化的OES数据中,了解到氟在钽上具有低复合概率,因此在室壁上损失的氟更少,这应该提供最均匀的过程,通过中心注入的“重”SF6在到达锅炉时不能很好地混合,结果是中心低蚀刻速率,在洁净室中,复合概率更高,并且中心注入的效果被完全抵消,这导致中心高蚀刻速率,这对于具有高复合概率的壁的反应器来说是典型的,在O2等离子体的情况下,没有观察到气体注入的影响,可能是因为O2分子的质量较小。
本文研究了室壁成分对刻蚀速率均匀性的影响。特别关注金属污染对等离子体均匀性的影响,因为一些金属如氧化钽不容易用标准清洗工艺从室壁上去除。一般来说,具有低复合概率的反应堆壁将在整个反应堆中产生最均匀的中性粒子分布,对于氯和溴,与阳极氧化铝相比,在钛和钽氧化物上观察到类似的复合概率,对于氟和氧,我们观察到,与阳极氧化铝相比,金属氧化物的再结合几率分别较低和较高,因此,金属蚀刻残留物会影响氟基和氧基等离子体中的蚀刻速率均匀性。
![]()