本文讨论并演示了痕量污染物分析仪的功能。该分析工具利用电喷雾飞行时间质谱仪对晶圆清洗溶液进行全自动在线监测。该分析仪通过其在正负模式下提供强(元素)和弱(分子)电离的能力,提供了关于金属、阴离子、阳离子、元素和有机物质的丰富信息。它旨在满足晶圆制造中日益复杂的新化学工艺的半导体工艺控制和产量管理需求。
介绍
亚微米器件技术对晶片清洗过程中可能存在的化学杂质高度敏感。金属污染是集成电路器件性能下降的主要原因,包括pn结泄漏增加、栅氧化层击穿电压下降和载流子寿命缩短。随着关键器件几何尺寸持续缩小至0.13 m以下,将湿化学清洗槽中的污染物严格控制在ppt(万亿分之一)水平变得越来越必要。
我们宣布了一种新的过程质谱工具,旨在满足这种测量需求。本文介绍了首次痕量污染物测量结果。
TCA科技
TCA系统与洁净室完全兼容,在计算机控制下运行,包括样品提取和制备以及与标准工厂数据系统的接口。飞行时间质谱的基本性质类似于其他质谱仪,因为它利用电场和/或磁场按照质荷比(m/z)分离空间中的带电物质。飞行时间质谱的平均分辨率为2000米/米,目前配置为以正离子模式(阳离子)在18至230米/秒的质量范围内工作。TCA系统与洁净室完全兼容,在计算机控制下运行,包括样品提取和制备以及与标准工厂数据系统的接口。飞行时间质谱的基本性质类似于其他质谱仪,因为它利用电场和/或磁场按照质荷比(m/z)分离空间中的带电物质。飞行时间质谱的平均分辨率为2000米/米,目前配置为以正离子模式(阳离子)在18至230米/秒的质量范围内工作。
金属污染的TCA测量
图1显示了100 ppt水平解决方案的典型频谱。在该分析中,TCA在正“苛刻”电离模式下运行。由于飞行时间质谱的高质量分辨率,元素峰,如镍、锌和铜,可以从相邻的有机峰中清晰地分辨出来。图2显示了三种溶液的平均定量结果(100ppt、50ppt和20 ppt)。存在的元素可以在100 ppt的水平上进行定量,无论它们是多同位素还是单同位素。一些元素也可以在较低浓度下定量,即,。50分和20分。图2中缺失的数据出现在当前测量条件下无法以足够精度测量物种的地方。
在这项工作中使用的设施和UPW的质量是我们在较低水平上对许多物种进行成功量化的能力的主要限制。在100 ppt分析中观察到高背景浓度的钙。污染源未知,但据信与人类或设施有关。

图1. 100 ppt NIST可追踪溶液的质谱,TCA以正“苛刻”电离模式运行

图2.加入NIST标准“储备”溶液至20、50和100 ppt的超纯水(UPW)的TCA分析。等级。定量预执行同位素稀释质谱(IDMS)。
在线测量使用TCA的过程化学
图3显示了用于处理生产晶片的SC1浴的第一次测量结果。该趋势图说明了在几小时内可以经济高效地获得的在线数据量(选择的元素在SC-1浴中的浓度相对于时间以小时为单位绘制)。在这种情况下,同时对15种元素的一个单一生产SC-1槽进行取样,趋势图中显示了3种元素。多达五个浴槽的采样频率是每个浴槽的五分之一。定量测量的速率约为每小时5个完整的多元素分析结果。这些结果表明,定量测量数据量可以在几个小时内常规且经济高效地生成。这些结果也证明了基于实际过程化学的统计有效过程控制决策的潜力。

图3. 铜、镍和锰浓度与。SC-1生产槽中的时间(小时)
潜在应用:湿清洁过程中有机物种和元素物种形成的TCA分析
半导体行业正在研究更环保、更具成本效益的清洁化学品。一种方法是使用现有清洁溶液的高度稀释版本,如改良SC1 (NH4OH:H2O2:H2O)。螯合物添加剂还通过最小化金属催化的过氧化氢分解来提高SC-1浴的稳定性。商业螯合剂之一,如滴定剂(乙二胺四乙酸,乙二胺四乙酸)通常用于此目的。
例如,使用“软电离”TCA分析来鉴定SC-1溶液中添加1ppm的表面活性剂CH3(CH2)7SO3Na中存在的分子种类,如图4所示。表面活性剂C7F15CO2H在BOE(缓冲氧化物蚀刻)和螯合剂EDTA中的质谱分别如图5和6所示。两个Cu在图5中,BOE情况下存在的物种来自一个未知的来源。图6中的光谱显示了C或C与各种Fe同位素结合的有机物种,即Fe、Fe和Fe。
尽管金属污染物分析可能仍然是镀液化学测量的主要目标,但直接元素形态和物种测量和鉴定提供的信息将有助于更好地理解所涉及的污染机制。本文讨论的底线是,关于过程化学还有很多未知的东西,新的清洁方法正在产生额外的复杂性。更好地了解现有的实际机制将有助于设计和成功实施更有效的清洁解决方案。
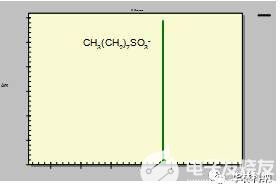
图4. SC-1溶液中1 ppm表面活性剂CH3(CH2)7SO3Na的光谱;TCA工作在软电离和负模式

图6. 乙二胺四乙酸铁的光谱,TCA操作在软电离和负模式
结论
我们已经证明,新的IPMS TCA能力能够识别和量化湿法清洁工艺解决方案中的阳离子或阴离子形式的金属和有机物质。在这种情况下,我们将这一能力应用于UPW和标准BOE、SC-1和DHF半导体工艺解决方案。我们还在包括表面活性剂和螯合剂的相对较新的稀释SC-1化学物质的分析物中显示了有机和物种测量能力。痕量污染物分析仪(TCA)的功能包括无需操作员协助的自动化在线操作。该工具提供实时过程化学测量,并具有提供元素和分子种类信息的能力。
预计这种新的高容量成本效益测量能力将首次提供统计上有效的过程化学表征和产量关联。该工具产生实时统计上有效的过程信息,从而避免偏移并采取必要的纠正措施。可以根据实际的工艺化学和污染水平以及对意外设备预防性维护的需求来确定槽的更新或更换要求。总体而言,这些能力将实现更好和更具成本效益的半导体工艺控制和产量管理。
![]()

