引言
紫外荧光(UVF)是一种新颖而通用的检测硅片表面金属杂质污染的方法。我们证明了UVF在硅片加工中污染控制的有效性。实验显示了室温下铁、铜、镍、钠等主要特征峰。与其他表面敏感技术相比,UVF的主要优势是低检测限、多元素同时分析和高灵敏度。
每个晶圆加工步骤都是潜在的污染源,可能导致缺陷形成和器件故障。晶片清洗必须在每个处理步骤之后和每个高温操作之前进行。一些金属杂质,如铁、铜、镍和钠,可能会在某些加工步骤中掺入硅片,如热氧化、反应离子蚀刻和离子注入。到目前为止,还没有任何可用的方法来同时检测铁和钠的污染。在此,我们首次报道了一种新的技术:紫外荧光(UVF ),它可以作为一种快速的、实际上无需制备的无损检测方法,用于评估VLSI晶片在实际工艺中的清洁性能。
实验
样品用记录荧光光度计测量。光源是氙气。测量系统完全由计算机控制,可以研究直径达6英寸的晶片。晶片上的测量面积可以在大约1×1和5×5 cm²之间变化。激发荧光单色仪的光栅常数为900/mm。它们对波长的测量精度可以达到2纳米以下。注入的紫外光束只透过硅表面约30纳米。所有测量都是在硼注入直拉(Cz)和浮动区(FZ)晶圆(直径3-6英寸)上进行的。所研究样品的硼浓度范围约为104-106cm-3,但主要使用了1-2×1015cm-3的样品。
结果和讨论
在UVF测量中,当激发波长在220-300纳米范围内时,我们获得了室温下300-400纳米范围内微量杂质铁、镍、铜和钠的特征峰。这些峰值波长分别为:铁371纳米、383纳米和398纳米,钠330纳米,铜325纳米和378纳米,镍341纳米和352纳米。图1显示了铁和钠污染的UVF光谱。由于纯硅不是300-400纳米范围内的荧光材料,所以它没有曲线(a)所示的特征峰。图2显示了失效的超大规模集成电路芯片的UVF频谱。
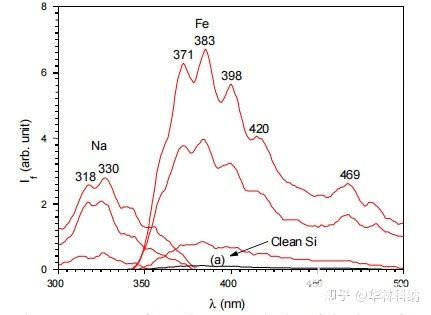
图1 热氧化后清洗晶片铁和钠污染的UVF光谱。曲线(a)是热氧化前的UVF光谱
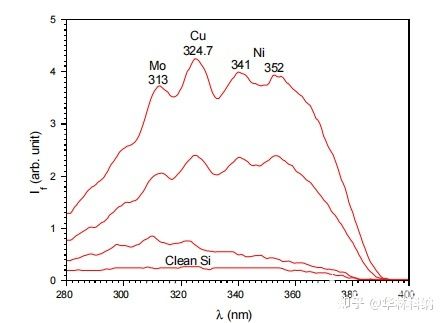
图2 失效超大规模集成电路芯片硅表面铜、镍、钼杂质的UVF光谱
如图3所示,UVF峰强度(If)与金属杂质的浓度(Ci)和荧光效率(φI)的乘积成正比。它们服从斯托克斯定律,当(Ci/Cmi)<<1时,可以写成方程(1),其中A为常数,Cmi为单晶硅的浓度。因此,硅片的清洁度水平可以根据上述光谱峰值强度进行评估。
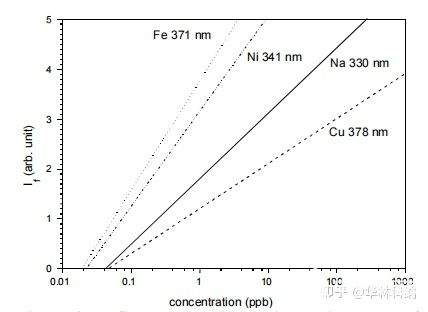
图3 显示了硅抛光表面的荧光峰值强度与杂质含量的关系
在图4中,少数载流子产生寿命τg随着氧化膜下硅表面附近铁杂质的增加而迅速下降。图5显示了在140℃退火120分钟的铁注入晶片上的铁的UVF光谱。图6显示了铁荧光强度与其离子注入剂量之间的关系。
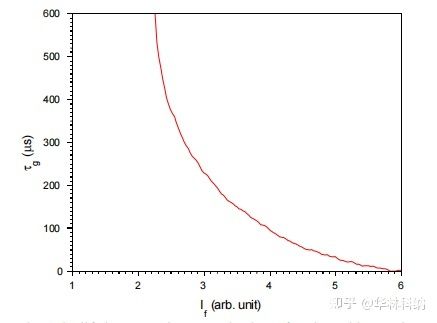
图4 寿命τg与热氧化物晶片上铁杂质污染的关系
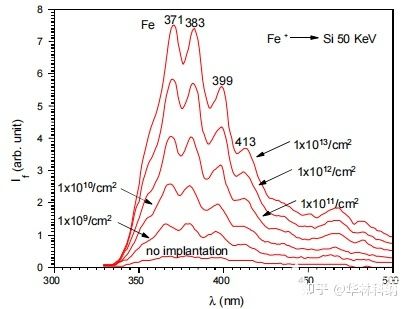
图5 在140℃退火120分钟的铁离子注入晶片的UVF光谱
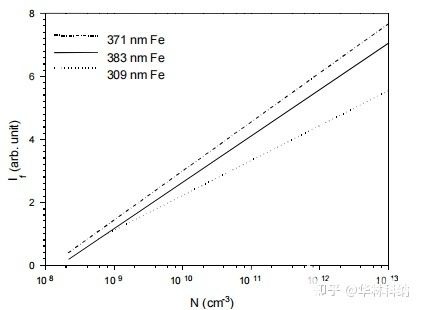
图6 铁荧光峰强度与其离子注入剂量的关系
最后,硅晶片清洁度(θ)的性能可以表示为方程(2):

其中Imi和Ii分别是标准样品和检测晶片上金属杂质的荧光强度。显然,金属杂质的含量越小,金属杂质的类型越少,晶圆表面的清洁度性能就越高。
结论
紫外荧光测量是检测硅片表面附近铁、铜、镍、钠污染的灵敏方法。结果表明,该方法在实际工艺中监测和评价超大规模集成电路晶片的清洁性能是简单有效的。
![]()