从智能手机到汽车,消费者要求将更多功能封装到越来越小的产品中。为了帮助实现这一目标,TI 优化了其半导体器件(包括用于子系统控制和电源时序的负载开关)的封装技术。封装创新支持更高的功率密度,从而可以向每个印刷电路板上安装更多半导体器件和功能。
晶圆级芯片封装方式 (WCSP)
目前,尺寸最小的负载开关采用的是晶圆级芯片封装方式 (WCSP)。图 1 展示了四引脚 WCSP 器件的示例。

图 1:四引脚 WCSP 器件
WCSP 技术使用硅片并将焊球连接到底部,可让封装尺寸尽可能小,并使该技术在载流能力和封装面积方面极具竞争力。由于 WCSP 尽可能减小了外形尺寸,用于输入和输出引脚的焊球数量将会限制负载开关能够支持的最大电流。
采用引线键合技术的塑料封装
需要更高电流的应用或工业 PC 这样的更严苛的制造工艺需要采用塑料封装。图 2 展示了采用引线键合技术的塑料封装实现。
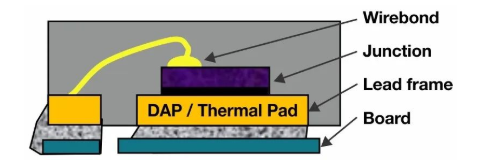
图 2:标准引线键合 Quad-Flat No Lead (QFN) 封装
QFN 或 Small-Outline No Lead (SON) 封装使用引线键合技术将芯片连接到引线,从而在为自发热提供良好散热特性的同时,让更大电流从输入端流向输出端。但引线键合塑料封装需要为键合线本身提供大量空间,与芯片尺寸本身相比,需要更大的封装。键合线还可增加电源路径的电阻,从而增加负载开关的总体导通电阻。在这种情况下,折衷方案是在更大尺寸和更高功率支持之间进行平衡。
塑料 HotRod 封装
虽然 WCSP 和引线键合封装都有其优点和限制,但 TI 的 HotRod QFN 负载开关结合了这两种封装技术的优点。图 3 展示了 HotRod 封装的分解图。
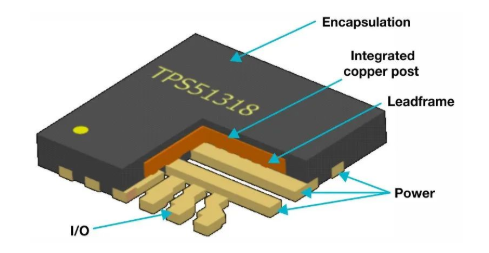
图 3:TI HotRod QFN 结构和芯片连接
这些无引线塑料封装使用铜柱将芯片连接到封装,因为这种方法比键合线需要的空间小,从而可以尽可能减小封装尺寸。铜柱还支持高电流电平,并且为电流路径增加的电阻极小,允许单个引脚传输高达 6A 的电流。
表 1 通过比较 TPS22964C WCSP、TPS22975 引线键合 SON 和 TPS22992 负载开关,说明了这些优点。
表 1:各种负载开关解决方案的比较

虽然 TPS22975 引线键合 SON 器件也可支持 6A 电流,但实现这一电流电平需要使用两个引脚来提供输入和输出电压,这会限制其他功能的数量,例如电源正常和可调上升时间。键合线还可增加器件的导通电阻,从而限制最大电流。
WCSP 负载开关是这三种解决方案中最小的,但其受限的引脚使其具有的功能最少,支持的电流最低。
结语
TPS22992 负载开关结合了 WSCP 和 SON 的优点,既具有 WCSP 解决方案尺寸小巧的优点,也具有引线键合 SON 解决方案的大电流支持和额外功能。TI 的 TPS22992 和 TPS22998 负载开关使用 HotRod 封装优化小解决方案尺寸,同时支持大电流、低导通电阻和许多器件功能。
![]()