介绍
RCA标准清洁,在去除硅表面污染方面非常有效。RCA清洁包括两个顺序步骤:标准清洁1(SC-1)和标准清洁2(SC-2)。SC-1溶液由氢氧化铵、过氧化氢和水的混合物组成,是迄今为止发现的最有效的颗粒去除剂。这种混合物也被称为氢氧化胺、过氧化氢混合物(APM)。SC-I溶液通过蚀刻颗粒下面的晶片来促进颗粒去除;从而松动颗粒,使机械力可以很容易地从晶圆表面去除颗粒。
本文将讨论一个详细的SC-I清洗的化学模型。了解导致氧化物同时生长和蚀刻的化学性质,为优化颗粒去除,同时尽量减少气体液体界面的形成提供了基础。
溶液化学
SC-1中晶片表面氧化物的生长速率由温度、过氧化氢浓度和pH决定。此外,由于活性物质在与硅反应之前必须通过现有的氧化物扩散,因此该反应是受运输限制的,因此是氧化物厚度的函数。氧化物的厚度随同时蚀刻和氧化物的生长而变化。因此,厚度是反应时间的函数。此外,识别最可能的氧化物种对于准确的氧化物溶液中氧化物生长模型是必要的。先前的分析表明,H202可能不是主要的氧化物种。
氧化物生长的浓度依赖性
在SC-1和H202溶液中发现了两种不同的氧化物质:H202和超氧化氢。这两种氧化剂的相对浓度在两种溶液之间存在很大差异。
其中CH202和CNH3是化学物质混合物的正式过氧化氢和氨浓度。实验结果表明,SC-1溶液的氧化速率远高于纯过氧化物溶液。SC-1中的最终氧化物厚度会在非常短的暴露时间后达到,而在过氧化物溶液中,只有在大约50分钟后才能获得类似的氧化物厚度。

图3:不同浓度下H202溶液中氧化物厚度随时间的函数
氧化物生长的时间依赖性
事实上,化学氧化物的最大厚度是9A,因为该氧化物是在SC-I或纯过氧化物溶液中产生的。由于氧化物在纯过氧化氢溶液和SC-1溶液中停止生长,数据表明其他一些运输限制可能是活跃的。在氧化物和硅之间的界面附近,与局部电荷相关的极化能可以直接影响带电物质的输运。界面上局部电荷的存在提供了一种动力,通过近距离扩散影响输运。
结果表明,A的符号为负的,说明阴离子是氧化膜生长过程中的活性氧化物质。这一证 据再次表明,超氧化氢是主要的氧化剂。
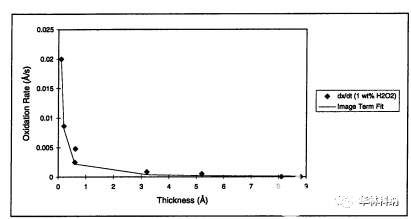
图6:实验数据(6)与图像电荷模型的比较
结论
氧化物的生长发生在纯物之间的界面上。硅和现有的氧化物,因此是一个运输有限的反应。本文对已发表的数据进行的分析表明,负责氧化物生长的主要氧化剂是过氧化物阴离子,超氧化氢”。数据表明,SC-I溶液的生长速度明显快于过氧化物溶液。在SC-1溶液中,超氧化氢由于氢氧化铵的存在而导致的浓度增加;因此,由于氧化剂浓度较高,生长速度更快。H20 2 在两种溶液中的浓度大致相同,因此如果H20 2 是主要的活性氧化物种,则预计两种溶液之间的生长速率不会发生变化。此外,任何一种溶液的增长率都与的浓度也与 成正比。这些比例关系表明,一个简单的一阶反应,或与超氧化氢的运输有限反应是氧化物生长的主要原因。最后,基于简单菲克扩散的模型无法拟合数据。相比之下,基于图像电荷离子输运的模型与实验误差范围内发表的数据一致。基于图像电荷输运的模型预测了经常观察到的氧化物厚度在8-10a左右的限制。超氧化氢-由图像电荷产生的离子力传输;而H202不受这种静电效应的影响。
![]()

