本文章提出了一种新的半导体超卤素深度分析方法,在通过臭氧氧化去除一些硅原子层,然后用氢氟酸蚀刻氧化物后,重复测量,然后确定了成分和表面电位的深度分布,因此这种分析技术提供了优于0.5纳米的深度分辨率,通过显示经反应离子蚀刻处理的p-Si(100)样品的成分谱结果,以及被1keVAr+轰击的n-Si(100)样品的表面电位谱数据,证明了该技术的适用性。
我们提出了一种新的硅切片方法,可以用来测量硅纳米地下区域的组成、结构和电学性能,该方法使用紫外(UV)臭氧氧化结合氢氟(HF)酸蚀刻,在每一步去除0.5nm的硅层,通过在每个去除步骤中插入RBS和XPS,得到深度分析,给出了该技术应用的两个例子,一个应用于反应离子蚀刻(RIE)后的p型Si(100)表面,另一个应用于1keVAr+离子轰击后的n-Si(100)表面。
氧化物厚度,SiO-Si界面突然的3HF蚀刻对去除氧化物有效,但对硅无效,紫外线照射不会在材料中引入任何结构缺陷,可以在不影响原始结构的情况下测量这些尺度内的结构性能。这种方法的一个优点是,在高频去除氧化层后,半导体表面被氢终止,氢抑制了在随后的空气暴露中的进一步氧化,虽然使用高频去除氧化层可能会引入氢相关缺陷,但这种缺陷预计不会改变近表面损伤结构,因为它们可以在中等温度下退火,事实上,高频钝化已经证明了在n-和p-Si上的平坦带表面的产生。
紫外臭氧氧化的处理方法如下:将通过去离子水浴的纯氧气体引入不锈钢反应室,在臭氧氧化前,用氧气净化室内5min,采用功率为75W的低压紫外灯启动臭氧氧化,每个氧化步骤持续20min,氧压为1atm,根据Si2p谱中氧化物、IIsi的光电子强度计算了氧化物tsii的厚度。
该光谱是在表面科学仪器SSX-100光谱仪上收集的,其x射线光斑大小为600pm,通过能量为50eV,假设硅和二氧化硅中的si2p光电子的IMFP均为2.5nm,相当于平均硅蚀刻深度为0.3=l=O。1纳米在深度剖面过程中,氧化层用5%HF溶液蚀刻I60s,然后用去离子水冲洗1min。为了校准蚀刻深度,我们将轮廓分析技术应用于通过分子束外延生长的Si/Ge/Si超晶格。通过良好校准后的生长参数确定,硅帽和锗标记层的厚度分别为4和0.5nm。为了确定每个氧化/蚀刻循环中硅的消耗量,我们在蚀刻前用XPS测量了SiO(和GeO)的数量,并将其转化为氧化物的等效厚度。结果汇总如图所示2。

为了证明所提出的技术的适用性,我们展示了之前暴露于CFd/02等离子体的p型Si(100)样品近表面残余损伤的分析结果。我们的XPS测量表明,紫外线辐射生长的氧化膜的厚度与未损伤的相同,每次蚀刻循环后用XPS测量表面电位也可以提供关于硅表面纳米区域的电特性的进一步信息。
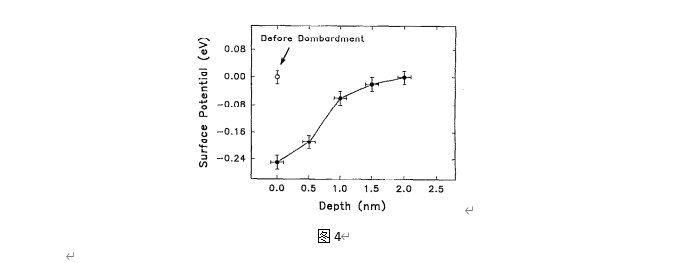
在本研究中,我们在室温下用1kev和6/cm2轰炸n-Si[(电子)=1×10‘6/cm3],然后通过一系列的氧化/蚀刻循环,对轰击样品进行XPS表面电位测量,在这些测量中,参考价带最大值的硅样品的表面费米能级位置等于样品的Si2p3,2结合能减去98.7eV,当表面费米能级处于价带最大值时硅的~结合能。结果汇总如图所示4,这表明在去除前2.5nm后,表面费米能级恢复到体值。对该纳米表面电位分析的研究当然需要澄清其适用性,我们相信其结果如图所示4展示了一种表征超卤素连接的新方法。
综上所述,我们开发了一种氧化/蚀刻技术,通过与RBS和XPS等方法的表面分析相结合,可以得到硅中杂质的深度分布和表面电学性质,其深度分辨率优于0.5nm。
![]()

