蚀刻机理
诸如KOH-、NaOH-或TMAH-溶液的强含水碱性介质蚀刻晶体硅通孔
硅+ 2 OH- + 2 H O 硅(OH) + H 二氧化硅(OH) 2- + 2 H
因为不同晶面的Si原子对于蚀刻反应具有不同的活化能,并且Si的KOH蚀刻不受扩散限制而是受蚀刻速率限制,所以蚀刻过程各向异性地发生:{100}和{110}面比稳定面蚀刻得更快
充当蚀刻停止{111}平面。
(111)取向的晶片
(111)取向的Si晶片几乎不受碱性溶液的侵蚀,因为在这里整个晶片表面形成蚀刻停止。因为晶片的实际取向通常相对于理想晶面倾斜几个±0.1°,对于名义上(111)取向的晶片,也会发生非常浅的台阶形式的蚀刻侵蚀。
(100)取向晶片
(100)取向的晶片在碱性蚀刻剂中形成具有{111}表面的基于正方形的金字塔。这些pyr- amids可以在单晶硅太阳能电池上实现,以达到反射最小化的目的。
(110)取向的晶片
(110)取向的晶片在碱性蚀刻剂中形成具有{111}侧壁的垂直沟槽,用作例如微机械和微流体中的微通道。
蚀刻速率
各向异性、绝对蚀刻速率和蚀刻的均匀性取决于
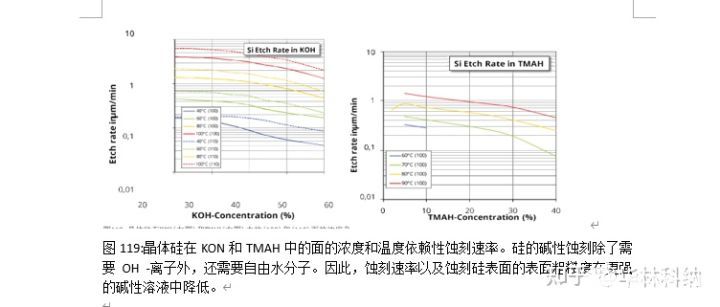
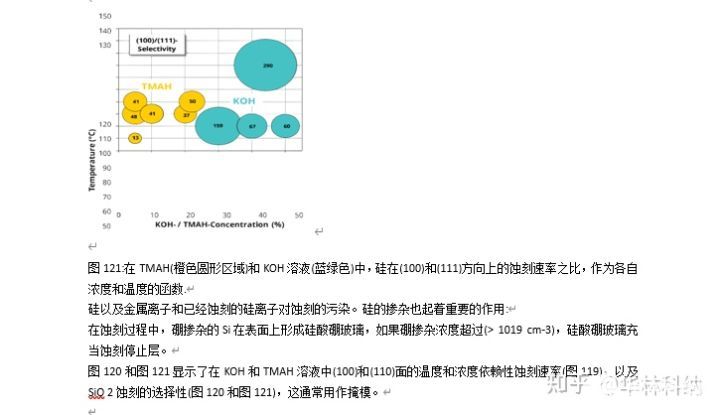
合适的蚀刻掩模
硅的各向异性蚀刻所需的高pH值和温度甚至会严重侵蚀在短时间内交联负性抗蚀剂,使得光致抗蚀剂掩模不成为此目的的问题。取而代之的是,使用通常由氮化硅、二氧化硅或诸如铬的碱性稳定金属膜制成的硬掩模,这些硬掩模又可以使用光致抗蚀剂掩模来构造。
硅的蚀刻速率
图122显示了室温下不同HF : HNO 3混合物中晶线硅的蚀刻速率。
当HF或HNO 3的浓度为-时,腐蚀速率下降到零非常低,因为在纯HF中没有SiO可以在HF和HNO 3中蚀刻的形式仅氧化硅而不蚀刻它。
蚀刻速率的精确控制要求温度精度在0.5℃以内。用乙酸稀释提高了疏水性Si表面的润湿性,从而提高了蚀刻速率的空间均匀性。
掺杂(n型和p型)硅显示出比未掺杂硅更高的蚀刻速率。
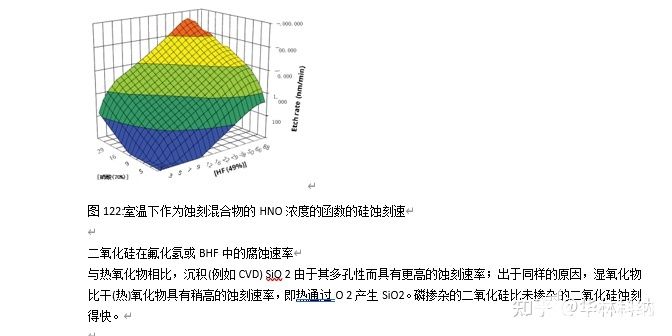
玻璃蚀刻
与SiO 2不同,各种成分的玻璃显示出它们的蚀刻速率与蚀刻中的添加剂之间的强依赖性。这种添加剂(例如HCl、HNO 3)溶解蚀刻过程中在玻璃上形成的表面膜,表面膜在HF中通常是化学惰性的,并且会停止或减缓用纯HF对玻璃的蚀刻。
因此,这种添加剂允许以恒定和高速率连续蚀刻。这允许在降低的HF浓度下提高蚀刻速率(=提高抗蚀剂剥离的稳定性)。
![]()