半导体制造的工艺过程由晶圆制造(Wafer Fabr ication)、晶圆测试(wafer Probe/Sorting)、芯片封装(Assemble)、测试(Test)以及后期的成品(Finish Goods)入库所组成。
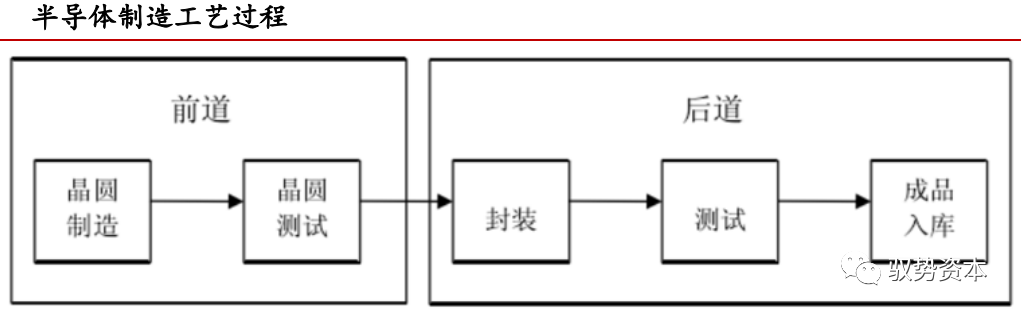
半导体器件制作工艺分为前道和后道工序,晶圆制造和测试被称为前道(Front End)工序,而芯片的封装、测试及成品入库则被称为后道(Back End)工序,前道和后道一般在不同的工厂分开处理。
前道工序是从整块硅圆片入手经多次重复的制膜、氧化、扩散,包括照相制版和光刻等工序,制成三极管、集成电路等半导体元件及电极等,开发材料的电子功能,以实现所要求的元器件特性。
后道工序是从由硅圆片分切好的一个一个的芯片入手,进行装片、固定、键合联接、塑料灌封、引出接线端子、按印检查等工序,完成作为器件、部件的封装体,以确保元器件的可靠性,并便于与外电路联接。
封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
随着汽车电气化和智能化的发展,中国汽车电子市场也正面临着新的机遇和挑战。汽车性能的不断提升不仅意味着更加先进的芯片设计,也意味着更先进的制造,封装工艺,其中也对芯片粘接技术提出了更高的要求。
![]()