随着高运算力的需求,系统级封装SiP客制化与高集成化的需求越趋增长,尤其是高密度整合后的系统级封装SiP有效连接晶圆到系统,是内连、整合、智能化的最佳解决方案,将带来更多应用上的优势,实现更高的经济效益。
日月光中坜厂SiP产品开发部部门经理杨绍纶日前在SiP China 2022苏州会议上指出,以TWS无线蓝牙耳机为例,在耳机狭小的空间里整合处理器、天线、传感器、电池、光学感应等面临多重挑战,包括电路设计时避免MCU、RF、电源以及喇叭之间的干扰,如何避免讯号同时在有限的体积内运作而干扰,目前的解决方案主要有以下3种:
1. 硬板(Rigid-PCB)
具有稳定的技术及高可靠性等优势,缺点是无法适应所有形状的耳机,3D结构分配灵活性低,需提高抗干扰能力
2. 软板(Rigid-Flex)
具有高灵活性、可匹配不同形状的耳机等优势,但是其基板层数有限,无法很好地隔离讯号、设计复杂等
3. 软硬结合板(Flex)
兼具硬板和软板的优势,具有非常出色的灵活性与可弯曲性,但在实际应用中会出现层堆栈能力有限、制程时间长、成本高等问题

日月光FPC系统级封装平台
以睡眠豆为例,日月光FPC系统级封装平台将六轴传感器、麦克风及天线等整合在软板上,只需2层软板即可完成所有功能的集成,并且没有讯号之间互相干扰与底噪问题,透过内结构的设计,把每个功能分布在其所需的位置上,使耳机组装更加迅速、简易。

系统级封装SiP在PCB硬板上同样具有独特的优势。当系统级封装SiP把信号整合在硬板上后,硬板上所需要的节点只剩下8个,即只需在这8个节点焊上各自所需功能的线即可完成耳机组装,使耳机成品集结更多的功能、更多不同的外形,让消费者有更多的选择方案。
系统级封装在硬件设计中的优势
QFN封装和BGA封装有很多I/O,因此基板设计的层数在实际制程时要求更高,但如果把主要器件的功能整合到系统级封装SiP之后,软板可以节省到只需两层即可把各个功能分布到其所在位置上,甚至可达到更宽松的基板技术需求,如线宽线距的需求等,让客户有多样性的选择。
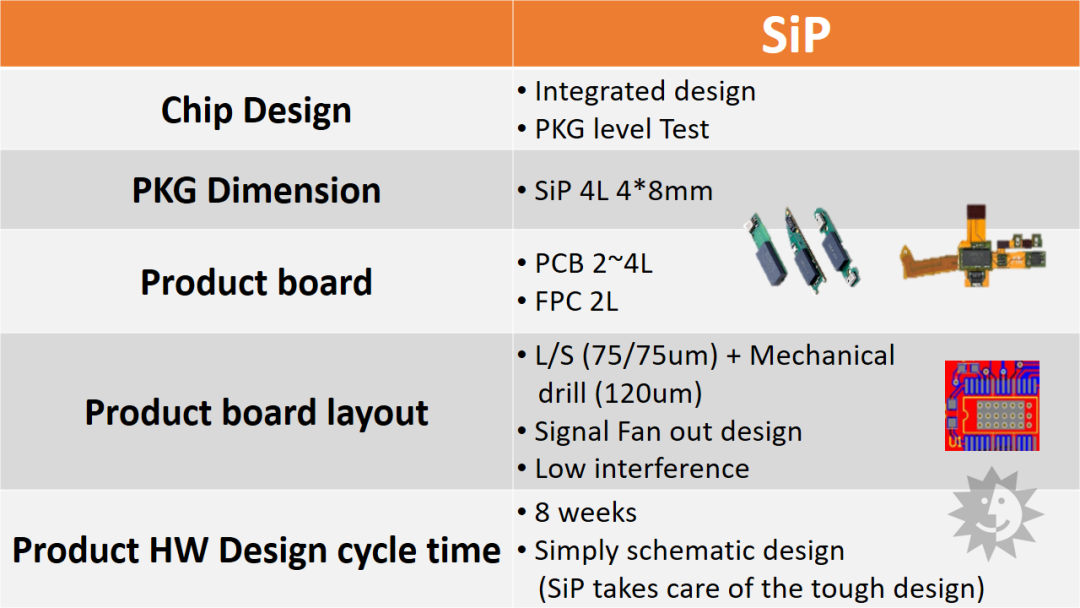
在设计时长上,以往产品的设计时长大致需要20周,但是运用系统级封装SiP解决方案可缩短设计时长至五周,大大缩短产品上市时程。以TWS SiP在实际应用为例,藉由声讯号测量可看到系统级封装SiP可解决天线、喇叭、麦克风在耳机内距离过近并同时运作造成的干扰, 让耳机底噪问题降到最低。
TWS无线蓝牙耳机使用蓝牙2.4G频段运作,但是在一些特定应用场景例如疫情防控、居家办公、在线观影等对网速要求不断提高,频率需达到WiFi6的6G,甚至WiFi7的7G。频率越高,讯号之间的互相干扰也随之提高,模拟分别在PCB基板与系统级封装SiP上做电路设计实验,显示在系统级封装SiP上的电路设计干扰会大大降低,大幅改善终端产品的使用体验。

系统级封装SiP微型化有著体积小、薄、讯号整合佳以及电池寿命管理佳等优势,但同时面临信号的调整度、散热需求、机械结构的外形大小与厚度,甚至供应链管理等挑战。日月光在系统级封装SiP领域耕耘多年,依靠扎实的工艺技术和突出的科技研发能力,为终端产品提供从设计、制造至营运的全面封装整合方案,与客户共同实现创新应用。
![]()

