本Inseto知识库文档介绍了光刻中使用的掩模对准器曝光模式。
基本步骤
微加工中使用的光刻技术在单独的文件:光刻基础中概述。
在本指南中,将提供更多关于涂层晶片或基板的曝光以及这如何影响光刻的细节
过程
光刻中使用掩模对准器将涂覆的晶片与掩模对准,然后将晶片暴露在紫外线下遮罩,如图所示:
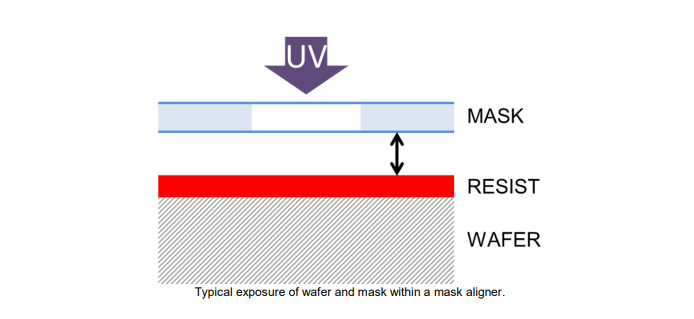
当将涂层基板暴露于紫外光时,用户可以选择许多称为曝光模式的选项。
通过掩模对准器,操作员能够精确控制掩模和晶片之间的间隙高度,称为“暴露差距”。增加或减小该间隙将影响图案化基板的最终分辨率以及吞吐量制造过程的影响。
曝光模式可分为两组:接触曝光和接近曝光。
常用的接触暴露模式有:
· 软接触
· 硬接触
· 真空触点
· 低真空触点
在接触模式下,掩模和晶片,顾名思义,接触,然后保持平行通过称为楔形误差补偿(WEC)的过程。然后将晶片和掩模移动到对准间隙,并相对于彼此定位。一旦掩模和晶片的对准完成,它们就被压在一起并暴露在紫外线下。按下的程度定义了曝光模式和可实现的分辨率。
曝光模式:软接触
在软接触中,晶片和掩模只是刚刚接触,没有施加进一步的力。
曝光模式:硬接触
在硬接触中,晶片和掩模接触,然后施加外力或压力将它们压成一体另一个使用的力的大小应由操作员确定。
曝光模式:真空接触
在真空接触中,晶片和掩模像硬接触一样压在一起,但随后在晶片和掩模之间产生真空面具使他们走得更近。这将产生最高分辨率的结果。低真空模式(有时称为软真空模式)减少了拉真空时对晶片和掩模的影响。这在易碎的情况下特别有用使用的基板容易断裂。
曝光模式:接近
接触暴露的替代方法是使用接近暴露。在这里,掩模和晶片从不接触,彼此分开另一个曝光间隙设置的范围从几微米到100微米不等,具体取决于机械的质量以及使用中的掩模对准器内的光学元件。在接近曝光范围内,甚至在没有晶片和掩模的情况下进行WEC触摸。
当我们从附近移动时;变软;努力;真空接触可实现的分辨率增加。这是因为作为晶圆和使掩模接触,使掩模到空气和空气到基板(分辨率较低)的衍射效应最小化/移除,直到暴露的图案与晶片的图案更精确地匹配,然而,反复接触会增加口罩污染和损坏的风险。这可能来自粒子以灰尘或其他有机和无机污染物的形式从基质转移到口罩;部分烘烤基板上的光刻胶残留物也会粘附在掩模上。在这些情况下,模式的保真度会受到影响并且降低了基板上的产率。为了克服这种污染,必须在经过一定次数的清洗后清洁口罩风险敞口。
掩模对准器内光学技术的进步导致了在大间隙下可实现的分辨率的提高,使接近度提高
曝光——当今生产环境中使用的最常见的曝光模式。
![]()