人们经常将Photo Lithography (光刻)缩写成Photo。得此名称的原因是,这个工艺在晶圆上利用光线来照射带有电路图形的掩模版,从而绘制电路。形成图形的方法类似于在洗印黑白照片时,将在胶片上形成的图像印在相纸上。
光刻工艺
光刻步骤类似于图案绘制的过程。而半导体的生产制造,可以理解为是重复的堆叠和切割。利用光刻工艺,在想要切割的位置绘制图案。
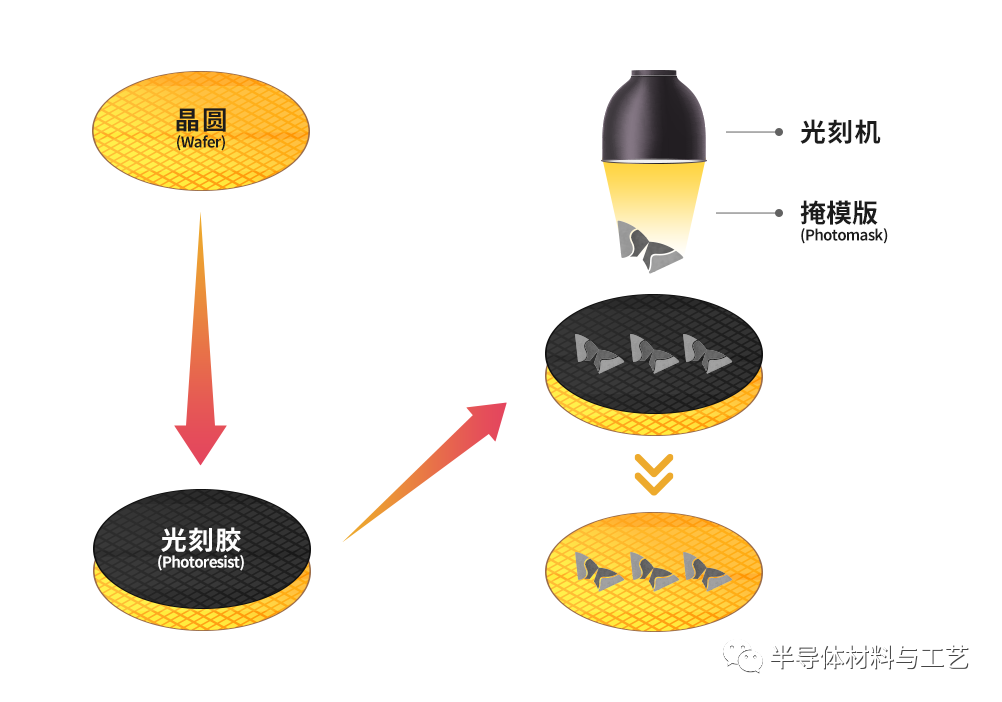
△光刻工艺基本步骤
光刻工艺的第一步就是涂覆光刻胶(Photo Resist,PR),当光穿过掩膜照射时,在受光和未受光区域之间,光刻胶会出现性质差异。利用这种差异,在光刻胶的受光或未受光区域中,可根据情况保留和移除所需区域,这个过程就是显影(Develop)。换言之,显影的区域便是掩模版的图案区域。将掩模版的图案(Pattern)显影在想要切割的物质上的过程,被称为成像(Patterning)。
光刻胶
光刻胶又称光致抗蚀剂,是指通过紫外光、电子束、离子束、X射线等的照射或辐射,其溶解度发生变化的耐蚀剂刻薄膜材料。为了获得更高质量的微电路图形,光刻胶膜必须薄且均匀,且对光要具有高度敏感性。

光刻胶经曝光后,其化学性质会发生改变。更准确地说,经曝光后,光刻胶在显影液中的溶解度发生了变化:曝光后溶解度上升的物质称作正性(PosiTIve)光刻胶,反之则为负性(NegaTIve)光刻胶。
半导体制造商一般会根据工艺的目的选择合适的光刻胶。例如,负胶经曝光而固化的部分,在显影过程中,因吸收部分显影液而容易膨胀、变形,不适合绘制精细图形。因此,绘制精细图形通常采用正胶。但负胶却具有成本低以及在刻蚀(Etching)工艺中抗刻蚀能力更强的的优点。
掩模版(光罩)
掩模版是用于LSI等集成电路制造工序的重要器件。在透明玻璃板表面的遮光膜上蚀刻加工了非常微细的电路图案,成为对硅晶圆复刻电路时的母版。
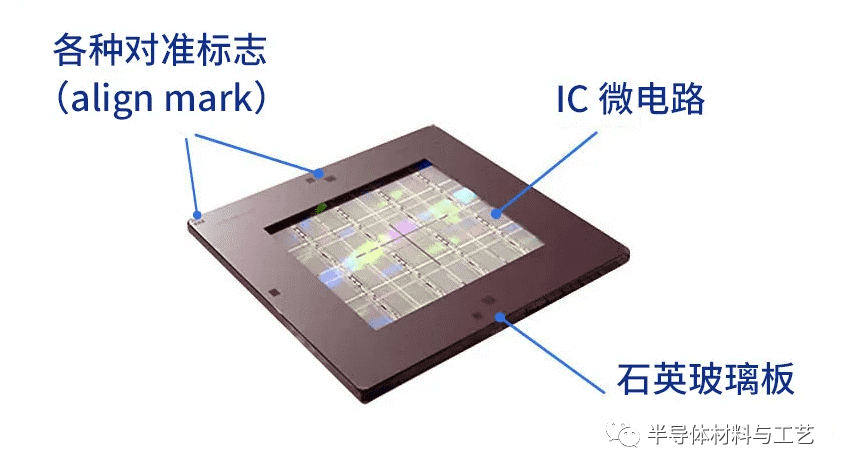
△光罩(Photo Mask)
将想要绘制的图案制成薄板(也被称为掩膜(Mask)或光罩(ReTIcle)),使用薄板让光被阻隔或者透射过去,照射在需要的位置,即可将掩模版的图案转印到晶圆上,从而显影出图案。
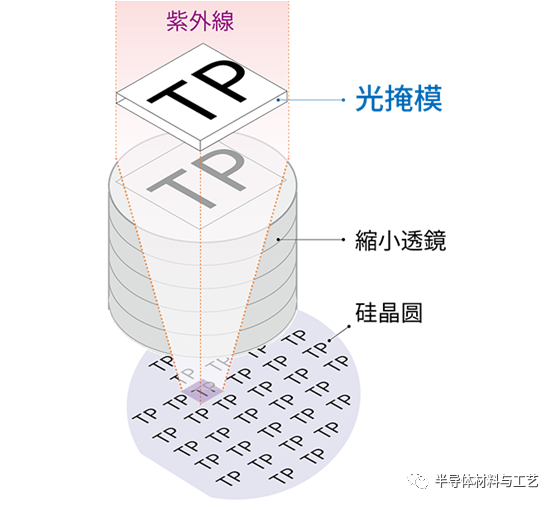
半导体制造需要多个掩模版。使用掩模版曝光后,在随后的刻蚀、沉积和氧化工艺中再经多种处理,然后再重复上述过程,堆叠半导体的下一层。可见,所谓“设计”,其实就是为赋予芯片一定功能,不断制作用于绘制半导体各层的掩模版的过程。
通过光线在晶圆上绘制电路的曝光
通过涂胶工序,形成光刻胶膜,使晶圆成为类似于相纸的状态后,使用曝光设备(步进式光刻机,Steper)使光穿过包含电路图形的掩模版,将电路印在晶圆上。这个过程叫做“曝光”(Steper Exposure)。半导体工艺中的曝光是指选择性地照射光的工序。
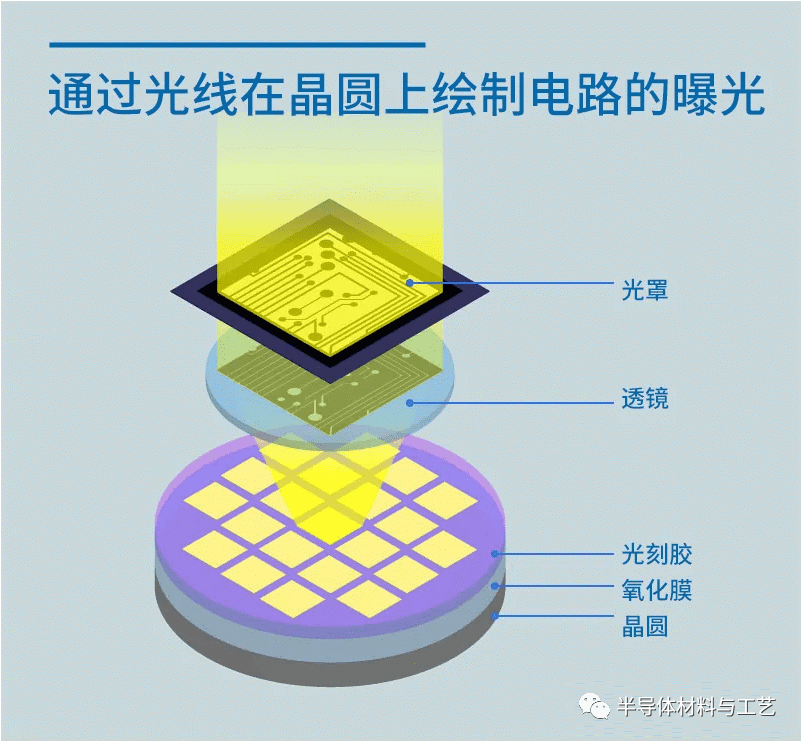
曝光与氧化工艺不同,无法同时处理数十个晶圆,即无法打造可以一次处理直径为300mm的晶圆的均匀光源,光刻机每次只能曝光1~4个芯片。仅投入到曝光工艺的资金就是氧化工艺的12倍。
形成电路图形的显影工序
光刻工艺的最后一个阶段是显影(Develop)。光刻胶曝光后,曝光区光刻胶的化学性质会发生改变,这些变质的光刻胶要用显影液溶解后去除,从而形成电路图形,这一工艺被称作显影。在正性光刻胶的情况下,留下未曝光的区域,而在负性光刻胶的情况下,仅使用曝光的区域。在进入显影工艺前,要进行曝光后烘烤(Post Exposure Bake,PEB),以进一步促进曝光区光刻胶的性质变化。
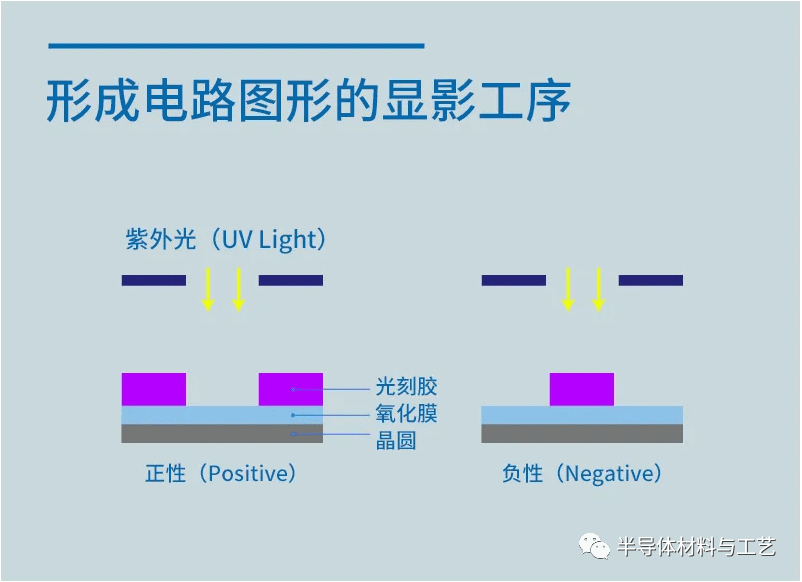
显影过程结束后,光刻工艺就完成了。在用各种测量设备和光学显微镜仔细检查图形是否绘制好之后,只有完成这些工序的晶圆才能进入下一个工程阶段。
随着半导体集成度的提高,晶体管的尺寸越来越小,构成芯片的单元元件也要使用微工艺做得更小。由于微电路图形的实现全由光刻工艺决定,因此集成度越高,光刻工艺中需要绘制的线条宽度也越来越窄,密度越来越大,这也就意味着光刻工艺的难度变得越来越大,就越需要更精细和更高级的技术。
![]()