半导体的清洗在制造工序中也是非常重要的。特别是光刻胶的去除是最困难的,一般使用硫酸和过氧化氢混合的溶液(SPM)等。但是,这些废液的处理是极其困难的,与环境污染有很大的关系,因此希望引进环保的清洗技术。因此,作为环保的清洗技术之一,以蒸馏水、臭氧为基础,利用微气泡的清洗法受到关注。
因此,作为其基础性研究,本研究的目的是,通过使用普通气泡的臭氧气泡和臭氧微气泡,测量各种光刻胶的去除速度,评价微气泡的清洗效果。
实验
实验装置的概略为图1所示,实验装置是无金属制的加压溶解型。装置的机理是用泵吸入水槽的水,同时使其吸入气体。对其加压后,通过减压释放使其产生微气泡。试料中,使用了只涂有光刻胶的状态的半导体晶圆。尺寸约为30四方,厚度约为1.将试料浸入水槽内的液体中,通过臭氧微气泡进行光刻胶的去除。同时,作为比较对象也进行了臭氧气泡的去除。此时,供试液体为蒸馏水。水温分别为27.7~30.3℃,30.0~30.9℃,气泡源使用臭氧气体。微气泡的排出压力为0.4 kPa.臭氧流量为1L/min。
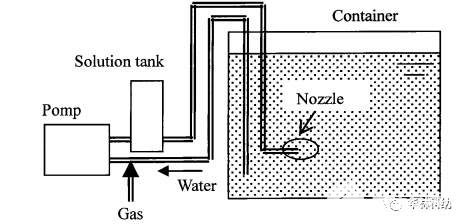
图1 微气泡发生器
在清洗评价方法中,使用了能量分散型荧光X射线分析装置,通过分析向试料照射X射线产生的荧光X射线的能量,将光刻胶的除去量换算成除去速度。
结果和总结
图2显示的是臭氧鼓泡和臭氧微气泡对光刻胶的去除速度。水中臭氧浓度的平均值分别为7.2 mg/L,2L2mg/L.臭氧鼓泡的情况下,在开始清洗的20分钟内显示缓慢的下降趋势,这是因为光刻胶具有疏水性。之后,可以看到几乎呈直线的减少趋势,120分钟内光刻胶被完全去除。另一方面,在臭氧微泡中,光刻胶在20分钟内被完全去除,与臭氧泡相比,去除速度约为6倍。
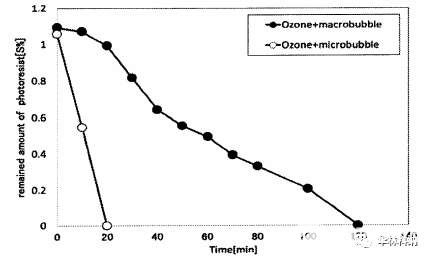
图2 光致抗蚀胶的去除效果
产生这种去除速度差的机理有两个。一个是水中臭氧浓度。光刻胶的去除速度与水中臭氧浓度成比例增减。这次,其浓度与臭氧气泡相比,臭氧微气泡的数值高出约3倍。第二个是由于微气泡的压坏现象造成的影响。可以认为,在光刻胶表面或者其附近,臭氧微气泡被压坏,此时产生的大量的羟基自由基对光刻胶进行了极其强力的分解去除,因此,由于这些的相乘效果,产生了6倍的去除速度差。
总结
通过臭氧微气泡进行半导体晶圆的光刻胶去除实验,评价了微气泡的清洗性能,其结果总结如下。1)臭氧微气泡具有比臭氧气泡大约6倍的光刻胶去除速度。2)去除速度差的机理,可以认为与水中臭氧浓度和微气泡的压坏现象有关。
![]()

