基本化学成分以Cl2为基础,外加用于侧壁钝化的N2。优化的ICP蚀刻工艺能够产生具有光滑侧壁的高纵横比结构。使用670nm波长的激光进行原位反射监测,以高精度在材料界面停止蚀刻。考虑到在基于GaSb的电子和光电子器件的制造中对高选择性湿法化学蚀刻剂的额外需求,还进行了广泛的研究以检验多种蚀刻溶液。列出了这些蚀刻剂的蚀刻速率、选择性和表面粗糙度,以验证它们对预期应用的适用性。尽管频繁使用GaSb或InAsSb材料用于彼此相对的蚀刻停止层,但是不希望其独特的II型破碎带隙对准的器件需要具有良好选择性的GaSb和AlGaAsSb之间的新的选择性湿法蚀刻剂。这里描述的所有湿法化学和干法蚀刻工艺都使用n型GaSb衬底进行了优化。
干法和湿法蚀刻工艺是重要的,并且广泛用于电子和光电子器件的制造。最近,由于广泛的新兴应用,人们对许多微米级和纳米级短波(SW-)和中波(MW)红外(IR)器件越来越感兴趣,包括晶体管[、光电二极管、发光二极管(led)和二极管激光器。在该波长范围内开发这些器件需要在GaSb衬底上的新型(AlGaIn)(AsSb)材料系统。
与III-v族如磷化物和砷化物相反,锑化物材料表现出一些不寻常的蚀刻行为,如由常用显影剂进行的不期望的弱蚀刻,蚀刻速率高达0.6 nm/sec,并且与大气氧的氧化速率非常快。还观察到氢氟酸(HF)蚀刻暴露于等离子体的锑化物,不同于其他III-V族化合物。此外,GaSb及其合金在通常用于其他III-V族化合物器件加工的湿法和干法蚀刻剂中表现出较差的选择性。由于强而快速的氧化,含铝材料不能用作蚀刻停止层。
作为标准实践,为了制造包括宽可调激光器的许多光电器件,例如取样光栅分布布拉格反射器(SG-DBR) 和垂直腔表面发射激光器(VCSEL),通常使用蚀刻停止层,以便以纳米级的高精度控制蚀刻深度。以这种方式,可以相对于另一层选择性地去除期望的材料。在宽可调的情况下激光,导致光子IC(PICs),其中有源和无源区域通过选择性湿法化学蚀刻来定义,多量子阱(MQW)区域从波导层的顶部被选择性地移除,从而定义低损耗无源波导。这通常通过具有蚀刻停止层的湿法蚀刻来完成,因为湿法蚀刻不会对激光器结构造成内在损伤。不仅如此,还需要良好的湿法蚀刻工艺来产生光滑的表面并蚀刻到正确的深度,以防止含Al层的暴露,这将使再生长变得困难,因为去除Al2O3是困难的。因此,开发可行的蚀刻工艺以在GaSb基材料中制造PIC兼容的宽可调谐激光器是至关重要的。
少数研究仅报告了锑化物材料的湿法蚀刻工艺[10,13–15]。然而,这些研究中提出的蚀刻剂清单并不完整,因为缺乏一些有用的湿法和干法蚀刻剂及其适用性、蚀刻停止层(InAsSb和GaSb除外)和四元合金蚀刻的信息。因此,依靠这些研究来开发广泛可调谐激光器和pic的稳健工艺是不可能的,需要更系统和彻底的研究。
蚀刻结果和讨论
3.1干法刻蚀
表1列出了蚀刻参数和相关的蚀刻结果,包括蚀刻速率和蚀刻掩模选择性。

图3示出了测量的反射率数据对蚀刻测试结构的蚀刻深度。随着材料被更多地蚀刻,反射率数据中的振荡强度逐渐增加;暗示在感兴趣的材料中有较少的光吸收。500 nm晶格匹配的Al0.5GaAs0.04Sb层末端的不连续是由于过渡到GaSb,轻微的不匹配可能是由于虚部不正确。根据拟合,不连续性似乎正好发生在层间转换处。因此,通过肉眼,可以看到激光监控图中各层的终点,并且应该能够清楚地看到第一个下降,其消光度低于AlGaAsSb下降,并从这一点开始计数。
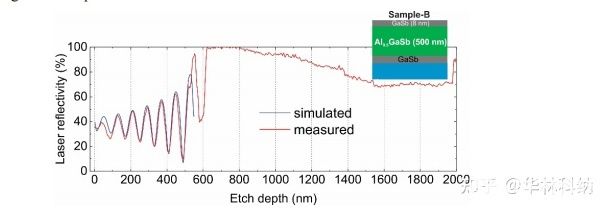
图3。测量的反射率数据对蚀刻测试结构的蚀刻深度-B .叠加模拟的激光监控信号以提取四元包层的折射率和消光系数值。
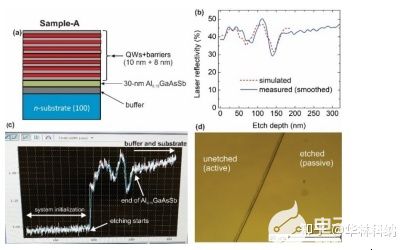
图5。(a)用于有源/无源定义测试的测试结构的示意图,(b)作为蚀刻深度的函数的模拟和测量(平滑)反射率数据被叠加;(c)在使用Cl2/N2等离子体的干法蚀刻过程中用于终点检测的系统的原始数据;以及(d)蚀刻后测试结构的显微镜图像,显示了有源/无源区域。
3.2湿法化学蚀刻
表2列出了许多蚀刻剂以及不同材料的蚀刻速率。最常用的湿法蚀刻剂之一是溶液-1。使用该蚀刻剂,GaSb、InAs和InGaAsSb被蚀刻成具有光滑的表面和良好的再现性。对于含铝层,当铝含量低(铝< 30%)时,这种蚀刻剂显示出快的蚀刻速率。对于溶液-2,我们发现与报告的蚀刻速率相同。最重要的是,通过这种解决方案可以从GaSb中选择性去除InAsSb。
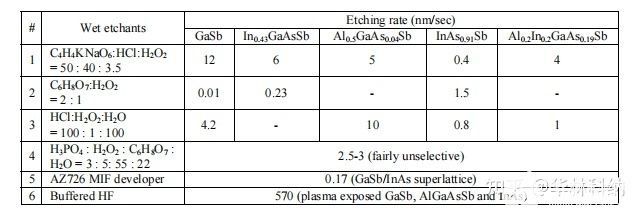
结论
探索了与GaSb晶格匹配的四元体的选择性湿法和干法刻蚀工艺。给出了有用的湿法蚀刻剂和干法蚀刻工艺。特别是,已经定义了与使用锑化物材料系统在SW/MW-IR波长范围内建立宽调谐SG-DBR激光器制造程序相关的材料和工艺。通过采用MQW InGaAsSb/AlGaAsSb/GaSb增益材料和必要的处理步骤,可以在包含MQW有源区的GaSb材料系统中开发PIC技术,该有源区通过使用蚀刻停止层的湿法或干法蚀刻或者通过时间控制的蚀刻被选择性地去除,如果通过干法离子蚀刻完成,则借助于激光监视器。这使得集成平台成为在一个芯片上结合有源和无源元件的最简单方式。事实上,许多其他光电器件的制造可以从本文概述的蚀刻和加工技术中受益。
![]()