引言
半导体制造业面临的最大挑战之一是硅的表面污染薄片。最常见的是,硅晶片仅仅因为暴露在空气中而被污染,空气中含有高度的有机颗粒污染物。由于强大的静电力,这些污染物牢固地结合在硅晶片表面,给半导体制造行业带来了许多令人头痛的问题。
为了正常工作,硅晶片必须完全没有任何污染物。然而,去除这些污染物并不是最简单的任务,因为硅晶片非常易碎。因此,半导体制造企业必须坚持精心制定的清洁计划,确保晶圆表面恢复到清洁状态,同时保持最小的损坏风险。
为了最有效地清洗硅片,硅酮制造商推荐以下清洗步骤:
第一步:溶剂清洗
半导体制造企业使用溶剂成功去除硅片表面的油和有机残留物。虽然溶剂确实能去除这些污染物,但溶剂本身也会在晶片表面留下残留物。由于这个原因,实施了双溶剂方法以确保晶片回到无污染状态。溶剂清洗方法概述如下:
准备两个浴槽,一个玻璃容器装有丙酮,另一个装有甲醇。
将丙酮容器放在加热板上,将丙酮加热至不超过55°c的温度。
一旦变暖,将硅片浸泡在丙酮浴中10分钟。
丙酮浴完成后,取出硅片并将其放入甲醇容器中5分钟。
时间一到,将晶片从甲醇中取出,在去离子水中冲洗。
用氮气吹干硅片。
第二步:清洁RCA-1
· 通过混合5份去离子水和1份氢氧化铵(27%)开始准备RCA槽。
· 将RCA容器放在加热板上,将溶液加热至大约70°c的温度。
· 一旦达到该温度,从热板上取下容器,并加入1份过氧化氢(30%)。一两分钟后溶液会冒泡。
· 一旦溶液开始冒泡,浸泡硅片大约15分钟。
· 时间一到,将晶片从RCA槽中取出,放入装有去离子水的容器中,多次换水以彻底冲洗溶液。
· 在此过程之后,在流动的水中从容器中取出晶片,以确保没有来自水面的残留物粘在晶片上。
第三步:氢氟酸浸泡
半导体制造企业然后实施最后一步,HF浸泡,以从硅晶片表面去除二氧化硅。需要注意的是,HF是一种危险的化学物质,因此硅树脂制造商建议在此步骤中始终穿戴防护装备,如厚手套和护目镜。HF浸渍工艺概述如下:
将480毫升水和20毫升氢氟酸混合,制成一个氢氟酸浸泡容器。始终使用聚丙烯烧杯,而不是玻璃烧杯,因为众所周知,当HF与任何玻璃材料接触时会发生危险的反应。
生成溶液后,将硅片浸泡2分钟。
时间一到,取出晶片,在流动的去离子水中冲洗。
通过将去离子水倒在晶片表面进行润湿性测试。如果水变成小珠子滚下来,你就知道表面是疏水的,没有氧化物。
用氮气吹干硅片。
执行硅酮制造商推荐的上述步骤将有助于半导体制造行业的企业克服硅片污染的挑战。
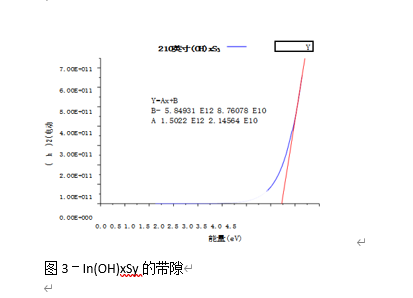
![]()