引言
我们华林科纳研究了三种化学溶液,用于在分布反馈激光器应用的InP外延生长之前清洗光栅。这些化学物质是浓缩的HMSO和n< SO,H2 2的混合溶液,其中n =β和
10. 在磷化铟衬底上,硫酸溶液的腐蚀速率比浓硝酸溶液快2-3倍H2SO,。H2 O—H2 2—h溶液各向同性地蚀刻光栅结构,并保留了原始的光栅形貌。然而,H2SO 4倾向于去除原始光栅的尖锐脊并降低分布反馈效应。我们还发现,在去除碳污染物方面,h2so 4-H2Ot-H溶液比HMSO 4更有效,碳污染物可以为位错环提供成核位置,并对激光二极管的可靠性产生不利影响。
介绍
最近,分布式反馈(DFB)激光器由于其稳定的发射波长和窄的谱线宽度而引起了人们的极大兴趣。这些性能属性对于许多光纤通信应用是重要的,例如高比特率、长距离光纤链路、波长复用和相干通信系统。DFB激光器的制造包括三个主要步骤:(I)光栅制造,(it)晶片清洗,在清洗过的晶片上过度生长异质结构层。DFB激光器的光栅制备和异质结构层过度生长已经在许多研究中被报道。然而,还没有任何关于在异质结构层过度生长之前清洗InP光栅衬底的文献。这里,我们描述了对DFB激光二极管制造质量至关重要的晶片清洗工艺。
正性光致抗蚀剂和聚甲基丙烯酸甲酯共聚物抗蚀剂通常用作光栅蚀刻掩模。在光栅被蚀刻后,抗蚀剂从衬底表面被化学去除。抗蚀剂的痕迹经常被捕获在光栅之间的窄槽内,并且会导致后续处理中的劣质外延生长。氧等离子体通常用于清洗残留的抗蚀剂,并且桶型反应器中的典型条件是在100℃下,在200毫托下,在300瓦的等离子体输入功率下持续20分钟。然而,来自氧等离子体的反应副产物通常被发现重新沉积在光栅表面上,并且必须使用湿法化学清洗工艺来去除这些反应副产物。尽管浓H2SO 4、酸和H2SO 4溶液,“H2 2”。和HCO 已经被用于清洁pla- nar InP衬底,但是还没有任何关于它们在清洁光栅表面中的应用的系统研究。在本文中,我们研究了这些解决方案在不显著改变光栅表面形态的情况下去除污染物的有效性。
结果和讨论
如图1所示,在氧等离子体剥离后,晶片包含轮廓分明的光栅结构。然而,在晶片表面上也发现了等离子体工艺的反应副产物。我们将报告两种清洗溶液,即H2SO 4和10 H2:H2O:HCO,在清除这些污染物方面的效果。图2(a)和(b)显示了在室温下在浓HZS 4溶液中分别清洗1分钟和5分钟的表面。如图2(a)所示,即使在很短的蚀刻时间(1分钟)后,精细光栅结构和污染物都消失了。在硫酸中蚀刻5分钟后,光栅轮廓的振幅降低到只有原始值(700A)。这个结果表明HMSO蚀刻InP各向异性,导致平滑的光栅特征;因此,它不适合用于清洁目的。更稀释的H2SO 4溶液只能降原始值(700A)。这个结果表明HMSO蚀刻。

我们将证明含H2O 2的溶液在去除碳污染物方面更有效。然而,很难直接在粗糙的光栅表面上比较这些清洁溶液的效果,如图2和3所示。相反,这些污染物很容易在V型槽通道的光滑表面上检测出来。因此,我们比较了两种不同溶液从光滑V形槽道中清除污染物的相对效率。光致抗蚀剂掩模用于制造V形槽沟道晶片(20)。在V形槽蚀刻之后,使用温丙酮去除光致抗蚀剂,随后类似于前面描述的清洗程序进行氧等离子体剥离。然后将晶片切割成四块。在25℃下,在这两种溶液中使用了两次清洁时间(5分钟和10分钟)。由这些溶液清洁的V形槽表面如图5(a)、(b)、(c)和(d)所示。在HMSO中清洗的表面显示出大量的污染物,在SEM显微照片上显示为黑点。然而,在用10°处理的晶片上获得了更清洁的表面。
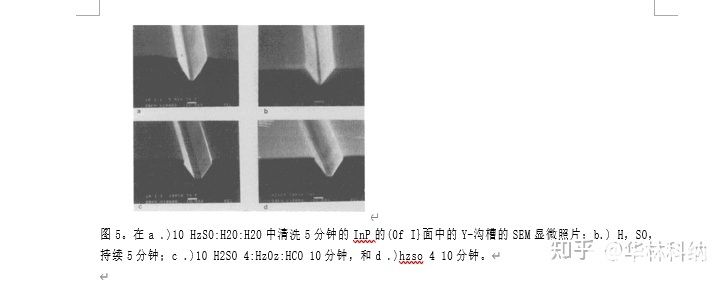

结论
我们华林科纳研究了用于激光应用的InP外延生长之前清洗匹配的两种化学溶液。这些化学物质是浓H2SO和nH,SO,H O H O的混合溶液,其中n =β和10。在lnP衬底上,HMSO——HCO——HCO溶液的腐蚀速率比浓HMSO——快2—3倍。HMSO—HCO—HCO溶液各向同性地蚀刻光栅结构,并保留原始光栅形态。然而,SOA倾向于去除原始光栅的尖锐脊,减少分布反馈效应。我们还发现HMSO、HCO、H2O溶液在去除碳污染物方面比HMSO有效得多,碳污染物可能为位错环提供成核位置,并对激光二极管的可靠性产生不利影响。
![]()

