摘要
硅(Si)的深度蚀刻对于广泛的应用是非常理想的。在这种情况下,通过长时间的金属辅助化学蚀刻(MACE)和短时间的氢氧化钾蚀刻,证明了通过蚀刻375微米厚的硅晶片的成本效益和可再现性。在MACE期间,除了酸碱度和温度、金属催化剂尺寸和覆盖密度在化学镀过程中起着重要作用。从镀液浓度和沉积时间方面优化MACE过程中的金沉积研究有效的贯穿蚀刻。发现30 s的HAuCl4浓度为∨5mM最适合于MACE,并且在Si中产生深度和高度致密的孔,阈值孔半径为∨250nm及以上。在MACE之后,氢氧化钾蚀刻有效地挖出多孔硅,通过蚀刻实现。
介绍
硅微加工被广泛用于图案和复杂三维结构的制造。引入表面微加工等新技术[1],各向异性蚀刻[2],LIGA进程[3]和博世流程[4]彻底改变了它的应用
方法由李和博恩报道[10].像金(Au)、银、铂和铜这样的金属在硅上的期望蚀刻区域中形成图案[11].由于金属的催化活性,金属附近的空穴浓度更高,这增加了这些区域的硅蚀刻速率。近年来,由于其低成本和对蚀刻形态的控制,MACE受到了广泛关注。CharTIer等人使用了摩尔
微流体中的阳离子和微机电系统
浓度比(ρ) = [HF] / ([HF] + [H2O2])
为了表征dif-
微机电系统器件等。通过干法和湿法各向异性蚀刻对硅进行深度蚀刻需要氮化硅/二氧化硅的硬掩模。许多技术和工艺如低压化学气相沉积(LPCVD)、等离子体增强化学气相沉积(PECVD)和热氧化是在受控环境中进行的,在受控环境中需要保持压力、气体流速、温度等以高质量生长Si3N4/SiO2 .考虑到生长过程中的许多可变参数,仪器的维护增加了生产成本。因此,使用聚合物作为掩模的简单湿法蚀刻技术对于许多研究人员来说是可行和有用的,而不需要这样的高端设备。硅的不等轴湿蚀刻是在含氢氧化物的溶液中进行的,其中具有不同杂化SP3轨道的晶面显著影响蚀刻速率.众所周知,在HF溶液中硅的各向同性湿法蚀刻是在存在空穴(h+)的情况下发生的,空穴是由氧化化学反应产生的,或者是在偏压下由外部提供.通过在所选几何形状中捕获空穴浓度,可以将蚀刻轮廓限制在特定区域。
在本工作中,我们报道了以化学镀金为催化剂,聚合物为掩膜对硅晶片进行刻蚀。采用长时间的MACE在硅中形成深而高密度的孔,然后进行短时间的氢氧化钾蚀刻,以挖出多孔硅并显示有效的蚀刻深度。优化化学镀金浓度和沉积时间,以在化学气相沉积过程中获得具有阈值孔径和良好覆盖率的高多孔硅。在硅片上制作的通孔可作为分析平面外接触光学探测器的窗口,并最适合高密度器件制造。
实验
实验中使用了电阻率为1-10ω-cm、厚度为375微米的掺硼P型硅晶片。晶片的抛光面具有厚度为200纳米的二氧化硅层。晶片被切割成
10 × 10 mm2件。样品通过在丙酮中超声清洗
10分钟,然后在乙醇中脱脂,最后用异丙醇和去离子水洗涤。通过浸入去离子水:氟化氢(100:1体积比)溶液中1分钟,对样品进行氢封端表面功能化。样品的预烘焙在110℃下进行2分钟。0.35毫米的聚甲基丙烯酸甲酯(分子量996,000)在三氯甲烷中的溶液用于在3000转/分钟下旋转涂覆90秒,样品在烘箱中在90℃下烘烤60分钟。通过曝光技术在聚甲基丙烯酸甲酯中产生1 × 4 mm2大小的窗口,并使用HF溶液蚀刻暴露区域中的二氧化硅。在硅表面的开窗口中进行化学镀金,时间分别为5、10、20、30 s,浓度分别为0.1、1、5和10 mM的氢氧化铝在5 M HF中。为了便于理解,在各种金盐浓度下进行金沉积处理的所有样品分别表示为0.1、1、5和10毫米的样品A、B、C和D,并使用样品(x、y)符号,其中y代表5、10、20和30秒的沉积时间。对于基于金覆盖率的蚀刻速率依赖性和蚀刻深度分析,所有样品的MACE在摩尔比为2.6 M HF和8.1 M H2O2的溶液中进行5小时。
结果和讨论
图1显示了在不同浓度的0.1、1、5和10毫米金前驱体中,通过化学镀在硅上沉积30秒的金的扫描电镜图像。对于样品(A,30),形成覆盖密度非常低的金纳米粒子簇,如所示Fig. 1a.图中的插图显示了在团簇形成过程中纳米颗粒的初始生长和种子生长。随着样品(B,30)中金属前驱体浓度的增加,团簇聚集形成金岛,衬底上的金属覆盖密度增加。样品(B,30)的插图显示了高度多孔的互连网络的生长,倾向于形成薄膜。对于样品(C,30)和样品(D,30),观察到金膜的形成。各图的插图显示,与样品(D,30)中形成的膜相比,样品(C,30)中形成的膜更多孔,具有更宽的裂纹。
图2 显示了镀金硅在不同摩尔浓度和30 s沉积时间下,经5 h MACE后多孔硅晶片的扫描电镜图像,以及孔半径分布。下图总结了
阈值半径(r)∞250nm及以上的平均孔半径和孔密度的行为。对于样品(A,30),MACE产生具有平均半径为140纳米的孔的波纹状硅表面,如下所示
如所示图. 2a.随着镀金浓度的增加,对于样品
(B,30)沉积金簇的尺寸增加,形成网络,覆盖密度增加(见图. 1b)。结果,形成了平均孔径为200 nm的更宽的孔,如所示图. 2b.类似的
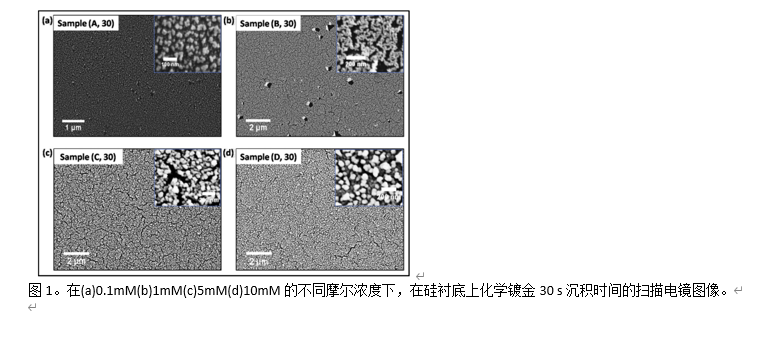

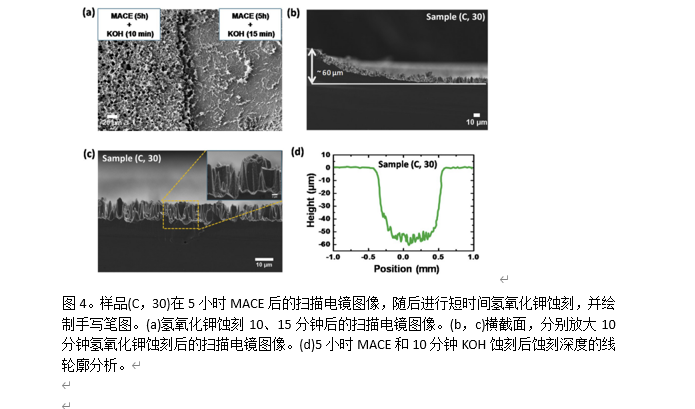
结论
采用等离子体刻蚀和氢氧化钾刻蚀相结合的方法研究了硅片的深度刻蚀。硅晶片的化学腐蚀采用不同摩尔浓度的化学镀金。使用探针轮廓仪根据金属覆盖密度分析蚀刻深度。高金属覆盖密度导致在硅中形成深、宽和高密度的孔
晶圆。摩尔浓度为∨5mM、沉积时间为∨30s的金沉积最适合硅晶片的穿透蚀刻。
![]()