引言
光增强电化学(PEC)湿式蚀刻也被证明可以用于GaN的蚀刻,但在大多数情况下,产生的表面非常粗糙。最近,氮化镓型采用了包括晶体湿化学蚀刻在内的两步法。这个过程包括一个传统的蚀刻步骤,如干式蚀刻,然后是第二个,晶体学的湿式蚀刻步骤。两步过程提供了平滑的表面,可用于创建下切、超切或垂直侧壁。然而,这种技术尚未被证明为p型氮化镓;本文报告了第一次p型氮化镓的晶体学湿法蚀刻。
实验
晶体蚀刻过程中两个蚀刻步骤中的第一个用于确定蚀刻深度,它可以通过几种常见的处理方法进行,包括干蚀刻、PEC蚀刻和裂解。这第一步是必需的,因为c平面(0001)对所有已研究过的化学制剂都不敏感,除了在发生蚀刻坑的缺陷部位。对于这里报道的所有样本,裂解已经被用作我们的第一步。第二步是通过浸没在能够晶体蚀刻的热化学蚀刻剂中来蚀刻氮化镓。
这个蚀刻步骤可以产生光滑的晶体表面,并且所产生的蚀刻平面可以通过改变第一步的方向、化学剂和温度来控制。采用金属有机气相外延法在c平面蓝宝石衬底上的气相外延生长了掺杂mg的p型氮化镓样品。样品由p型氮化镓层组成,载流子浓度由霍尔测量确定为7 31016 cm2 3,生长在300 A AlN缓冲层上的未掺杂高电阻率层上,总厚度为2-2.5mm。
蚀刻是在热盘子上的耐热玻璃烧杯中完成的。温度通过浸在样品旁边的热电偶进行监测,温度精确度在58摄氏度以内。在熔融的氢氧化钾、氢氧化钾溶解在乙二醇、磷酸和四乙基氢氧化铵(TEAH)中显示了结晶蚀刻。蚀刻发生在“水平的”,即,正常于[0001]。
然而,用扫描电子显微镜(SEM)测量的氮化镓epi层的厚度没有变化。因此,在“垂直”[0001]方向上的蚀刻速率至少比在水平方向上的蚀刻速率低两个数量级。由于c平面不受本研究中使用的所有化学物质的影响,因此晶体学蚀刻步骤不需要蚀刻掩模。c平面本身作为一个掩模。然而,为了防止在缺陷部位出现蚀刻坑,可能需要一个蚀刻掩模。为此目的,我们已经成功地使用了60纳米厚的镍掩膜在氮气中650℃退火2 min后,在氮气气氛中900℃退火30s后。退火后的镍掩模可以通过在1:1:3的盐酸、硝酸和水溶液中蚀刻去除,退火后的钛掩模可以通过在缓冲的氧化物蚀刻剂中蚀刻去除。去除口罩后,未观察到表面损伤。
结果和讨论
p型氮化镓晶体湿蚀刻后观察到的两个蚀刻平面的扫描电镜图像如图1所示。只有epi层的顶部部分是掺杂的p型的;下面的1毫米是未掺杂的。图1中所示的表面的无缝形貌表明,掺杂量的变化并不影响蚀刻平面或蚀刻速率。磷酸、TEAH、氢氧化钾在乙二醇和氢氧化钾熔融条件下形成的最常见的蚀刻面为{101w2 w},如图1a所示。在熔融的氢氧化钾中蚀刻后,也可以观察到图1b中所示的{101w0}平面。
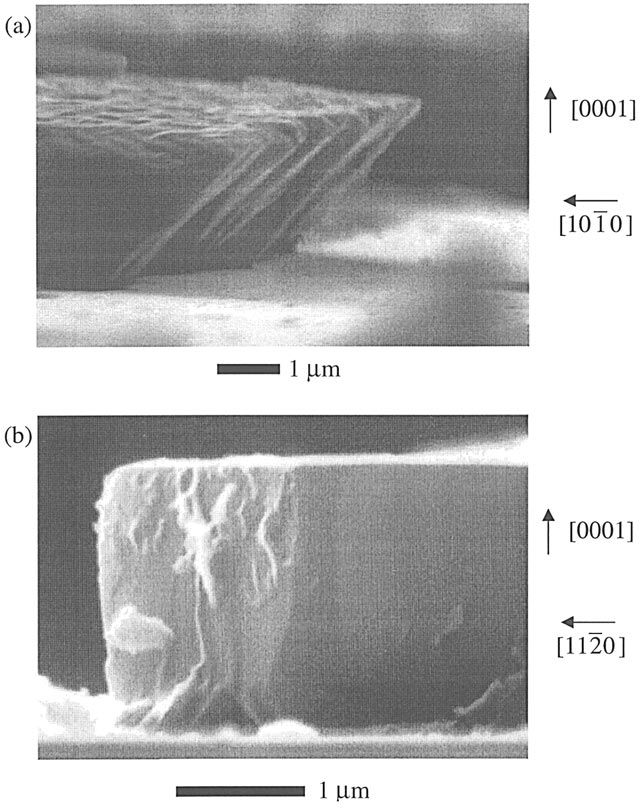
图1.湿蚀刻氮化镓晶体表面的扫描电镜图像.
从p型氮化镓和图2中的阿伦尼乌斯图可以看出,熔融氢氧化钾和n型氮化镓的蚀刻速率和活化能几乎相同。两种样品的活化能均为21千卡/摩尔,或0.9 eV。在图2和图3中,每个样品在任何给定的温度下都记录了两种不同的蚀刻速率。在沿氮化镓{1120} a平面切割的晶片一侧测量较快的蚀刻速率,在沿氮化镓{1010} m平面切割的晶片一侧测量较慢的蚀刻速率。从图3的阿伦尼乌斯图推断,乙二醇中30%氢氧化钾的活化能为21千卡/摩尔,或0.9 eV,磷酸的活化能为33千卡/摩尔,或1.3 eV。对于所有使用的蚀刻剂,活化能等于或略高于氮化镓的计算生成热,为0.90 eV。这些高活化能表明蚀刻是反应速率有限的。如果蚀刻速率扩散有限,活化能预计在16千卡/摩尔范围内。
图2。熔融氢氧化钾中n型和p型氮化镓蚀刻速率的阿伦尼乌斯图

图3.用乙二醇溶解的磷酸和30%氢氧化钾中p型氮化镓蚀刻率的阿伦尼乌斯图。
结论
一种晶体学湿式化学蚀刻技术能够以垂直于生长方向高达1.2 mm/min的速率蚀刻p型氮化镓。蚀刻的活化能在磷酸中为33千卡/摩尔,在氢氧化钾和在乙二醇中溶解的氢氧化钾中为21千卡/摩尔。在四乙基氢氧化铵中也实现了蚀刻。观察到的晶体学氮化镓蚀刻平面分别为(0001)、{10w10}和{101 w2 w}。由于氮化镓的c面不受蚀刻剂的影响,除了防止脱位时蚀刻坑的形成外,不需要蚀刻掩模。当需要时,退火镍和退火钛即使在本研究中使用的最高温度下也是有效的掩膜。p型材料的蚀刻率与之前研究过的n型材料相似。未掺杂GaN/p型氮化镓均型结无缝蚀刻,可以形成垂直的侧壁或下切的侧壁,这取决于所使用的化学性质。与电导率类型无关的蚀刻光滑垂直侧壁的能力表明,晶体蚀刻可用于制造氮化镓基激光二极管的切面。
(文章来源:jf_01960162)
![]()

