引言
氮化铝(AlN)和氮化铝钠(ScxAl1-xN)是一种压电材料,在压电微机电系统(压电mems)中具有重要的应用价值。这些材料的主要应用是在电信的声学滤波器上,但许多其他基于它们的MEMS设备正在出现。本文的目的是开发一个ScxAl1-xN的模式形成过程。本文首先对AlN和ScxAl1-xN的性质进行了讨论。然后介绍了湿法和干法蚀刻工艺的基本原理。接下来,讨论了基于等离子体的化学工艺在蚀刻和沉积材料中的应用。简要介绍了反应性磁控溅射法对AlN和ScxAl1xN薄膜的沉积作用,并对其刻蚀问题进行了详细的讨论。
实验
实验工作的重点是发展用反应性磁控溅射沉积的ScxAl1xN薄膜的湿法蚀刻工艺。ScxAl1-xN可以在酸性和碱性溶液中进行蚀刻。本研究选择了四甲基氢氧化铵(TMAH)、磷酸和硫酸溶液。
蚀刻过程可以是各向同性的,也可以是各向异性的(图3a,b)。各向同性蚀刻在每个方向上均匀地处理蚀刻材料,而各向异性蚀刻最好只在一个方向上进行。大多数湿式蚀刻工艺是各向同性的,而大多数RIE工艺是各向异性的。各向异性过程显然是高保真模式的首选。各向同性蚀刻过程将从掩模材料下面的侧面蚀刻材料,这被称为6下切。侧壁角是基底平面与侧壁之间的夹角。对于理想的各向异性蚀刻,它是90°。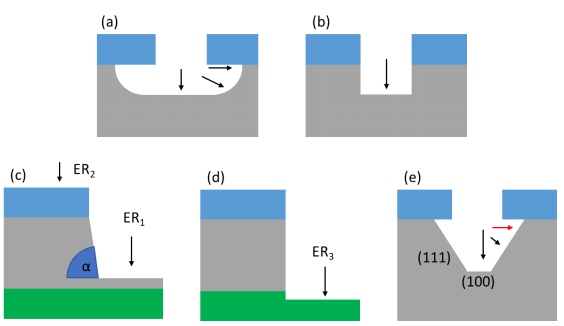
图3。(a)理想的各向同性蚀刻在各个方向上均匀地进行。(b)理想的各向异性蚀刻只进行一个方向。(c)各向异性蚀刻与侧壁角α。目标材料的蚀刻与掩模之间的选择性为ER1:ER2。(d)蚀刻成底层材料,蚀刻速率为ER3。(e)由结晶平面定义的湿式蚀刻,由于界面缺陷造成的掩模凹陷用红色突出显示。
结果和讨论
氢氧化钾或TMAH湿蚀是各向异性湿蚀的一个重要例子,广泛应用于硅的各种结构和设计。20不同的硅晶平面有不同的反应活性,导致不同的蚀刻速率(图3e)。硅平面的蚀刻速度非常快,而硅平面的蚀刻速度是最慢的,而{100}平面的蚀刻速度是中等的。21不同平面蚀刻的活化能也有所不同,其中蚀刻{111}平面的活化能最高。因此,硅的蚀刻形成了由{111}平面定义的结构,而其他平面则被蚀刻掉。这导致侧壁角为57.74°。AlN和ScxAl1-xNAl与碱性和酸性蚀刻剂的蚀刻也具有各向异性。各向异性湿蚀刻往往导致一些面削弱。例如,它可能是由最稳定的平面的蚀刻,或由掩模和蚀刻材料之间的界面缺陷引起的。
湿蚀刻和干蚀刻有几乎相反的优缺点。湿式蚀刻通常相当便宜,同时也可以进行大量晶片的加工。湿蚀刻方案通常对所需材料具有高度选择性。最大的缺点是湿法蚀刻通常是各向同性的,所以侧壁角难以控制,而下切会导致图案偏离掩模。此外,毛细管力在湿蚀刻中可能是一个问题,它们会导致非常精细的特征坍塌或相互粘附。最后,如果存在天然氧化物或其他残留物,则湿式蚀刻的高选择性可能会导致蚀刻起始过程中的不可靠性。另一方面,干式蚀刻技术需要昂贵的设备。在RIE和IBE中,通常一次只能处理一个晶圆,而选择性可能是一个问题,因为它们会相当迅速地蚀刻各种材料。然而,对于RIE和IBE,很少发生切割,侧壁角度可以通过调整蚀刻配方来控制。
在ICP系统中(图5),等离子体是由放置在腔室外的线圈产生的。对线圈施加射频功率会产生磁场,进而在等离子体中产生循环电流。在立方最密堆积系统中使用了一个单独的底部电极。施加在该电极上的功率控制着独立于ICP功率的直流偏置。与立方最密堆积相比,这使得可以更好地控制直流偏置和离子电流。
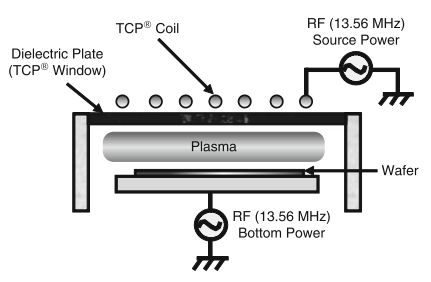
图5。ICP-RIE的结构。TCP是指变压器耦合等离子体,它使用平面线圈代替螺旋线圈。
结论
在横向蚀刻需要最小的应用中,在使用湿式蚀刻形成AlN或ScxAl1-xN之前,仍有许多问题需要研究。首先,应该研究钪浓度对蚀刻速率的影响。其次,对于器件64 65的应用,AlN或ScxAl1-xN通常沉积在金属底电极上。这可能会影响薄膜的蚀刻和视锥体的形成。第三,应优化退火温度,以最小化横向蚀刻速率,同时也应优化应力变化和压电性能。此外,还应研究不同x和不同衬底在退火过程中应力变化的来源。
(文章来源:jf_01960162)
![]()